因为专业
所以领先
BGA(Ball Grid Array Package)是一种先进的电子元器件封装技术,因其高密度、高可靠性以及优良的散热性能而在多个领域得到了广泛的应用。以下是BGA封装的关键技术:
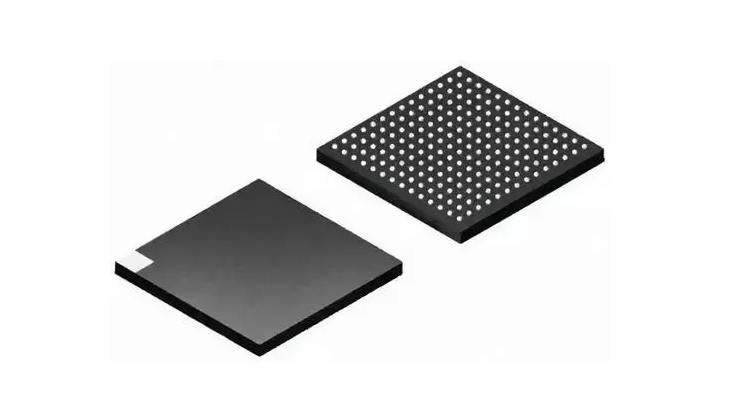
BGA封装技术是通过在芯片底部的基板上制作阵列,利用球形焊点作为电路的I/O端与印刷线路板(PCB)实现互接。这种表面贴装型器件的设计使得引脚间距得以增大,引脚数量增多,且引脚共面性好。相较于传统的引脚式封装,如DIP和QFP,BGA封装采用小球形焊点取代了宽大铜质引脚,从而极大地提高了芯片的集成度和性能。
BGA封装主要有以下几类:
FBGA(Fine-Pitch BGA):细间距BGA,锡球针脚密度更大,体积更小,容量更大,散热更好,更适合于内存与显存颗粒的封装。
MBGA(Micro BGA):微型BGA,与FBGA实际上是一样的,只不过称呼的侧重点不同,MBGA侧重于对外观的直接描述。
PBGA(Plastic Ball Grid Array Package):塑料焊球阵列封装,采用BT树脂/玻璃层压板作为基板,以塑料环氧模塑混合物作为密封材料,焊球为共晶焊料63Sn37Pb或准共晶焊料62Sn36Pb2Ag,目前已有部分制造商使用无铅焊料。
UFBGA或UBGA(Ultra Fine Ball Grid Array):极精细BGA封装。

BGA封装的工艺流程主要包括以下几个步骤:
圆片减薄:为了减轻芯片的重量和厚度,使其更适合封装。
圆片切削:将减薄后的圆片切成单独的芯片。
芯片粘结:将芯片粘结到基板上。
等离子清洗:清洗芯片和基板,以确保后续工艺的顺利进行。
引线键合:将芯片的引线与基板上的焊盘连接起来。
模塑封装:将芯片和引线封装在塑料环氧模塑混合物中,以保护芯片和引线不受外界环境的影响。
装配焊料球:在芯片的I/O端装配焊料球,作为电路的I/O端与PCB实现互接。
回流焊:通过回流焊将焊料球固定在PCB上。
表面打标:在封装表面打标,标识芯片的型号和其他信息。
分离:将封装好的芯片从基板上分离出来。
最终检查:对封装好的芯片进行全面检查,确保其质量和性能。
测试斗包装:对合格的芯片进行测试,并将其包装在测试斗中,以便后续的使用和运输。
BGA封装因其独特的优势,在多个领域得到了广泛的应用。在手机领域,随着智能手机功能的不断增强,对处理器的性能和功耗要求也越来越高。BGA封装芯片以其高度集成、体积小、性能稳定的特性,成为手机制造中的理想选择。它可以用于处理器、显卡、主板芯片组等关键部件,提供强大的计算和图形处理能力。同时,BGA封装芯片的高可靠性也确保了电脑系统的稳定运行,提高了用户体验。
BGA封装具有诸多优点。首先,其引脚短、组装高度低,使得寄生电感、电容较小,电性能优异。其次,BGA封装集成度高,引脚多、间距大,有效提高了电路的可靠性。此外,BGA封装还具有良好的散热性能,使得芯片在工作时温度更接近环境温度,提高了芯片的使用寿命。然而,BGA封装也存在一定的局限性,例如其生产制造成本相对较高,对生产工艺和设备的要求也较为严格。
在BGA封装的生产制造过程中,需要特别注意以下事项。首先,为确保生产过程的洁净度,产线上的工作人员必须佩戴防静电手套,禁止直接用手接触PCB及BGA。其次,要确保生产设备的精度和稳定性,以确保封装质量和性能。最后,要定期对生产设备和工艺参数进行检查和调整,以确保生产过程

BGA植球后焊膏清洗:
BGA植球后清洗:在BGA植球工艺,无论采用助焊膏+锡球的植球方法还是采用锡膏+锡球的植球方法,焊接后都会留下导致电子迁移、漏电和腐蚀风险的焊后残留物。需要通过清洗工艺将风险降低,提高可靠性。
W3110是一款碱性水剂清洗剂,W3110是一款针对电子组装、半导体器件焊后、晶圆封装前清洗而开发的一款碱性水基清洗剂。改产品能够有效去除多种助焊剂、锡膏焊后残留物,清洗包括电路板组装件、引线框架、分立器件、功率模块、功率LED、倒装芯片和CMOS焊后的各种助焊剂、锡膏残留物。
W3100为浓缩型水基清洗剂,用去离子水按一定比例稀释后使用,可试用于超声波、喷淋工艺,配合去离子水漂洗,能达到非常好的清洗效果,清洗后的表面离子残留物少、可靠性高。
产品特点:
W3110水基清洗剂处理铜、铝、特别是镍等敏感时确保了极佳的材料兼容性,除金属外对各种保护膜也有很好的兼容性。这款清洗剂非常低的表面张力能够有效去除元器件底部细小间隙中的残留物,并能够轻易的被去离子水漂洗干净。
W3110是一款浓缩液水基清洗剂,可根据残留物的可清洗难易程度,按不同比例进行稀释后使用,稀释液无闪点,其配方中不含任何卤素成份且气味小。
推荐使用 水基清洗剂产品!


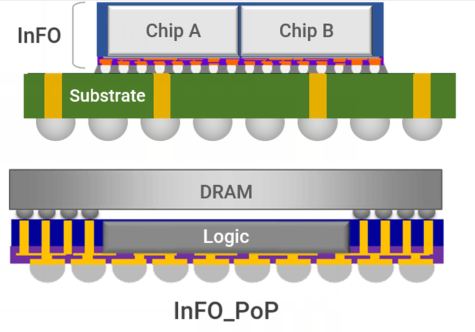
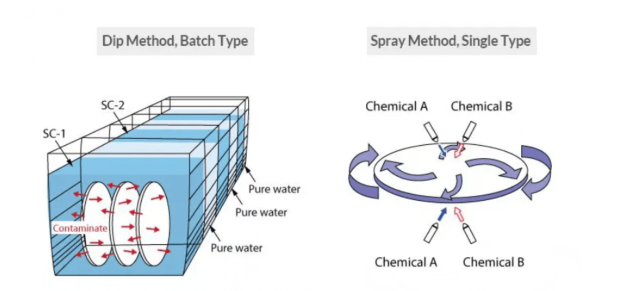

![[x]](/template/default/picture/closeimgfz1.svg)