因为专业
所以领先
扇入型和扇出型晶圆级封装有什么区别
晶圆级封装简称WLP,是一种在晶圆级别进行封装的技术。与传统的芯片封装方式相比,WLP技术具有更高的集成度、更小的封装尺寸和更低的成本。它通过将多个芯片或器件集成在一个封装体内,从而实现更高的性能和更小的体积。
晶圆级封装技术有两种不同的封装方式,一种是扇入型封装,一种是扇出型封装。下面 小编来深入探讨一下扇入型和扇出型晶圆级封装有什么区别,希望能对您有所帮助!
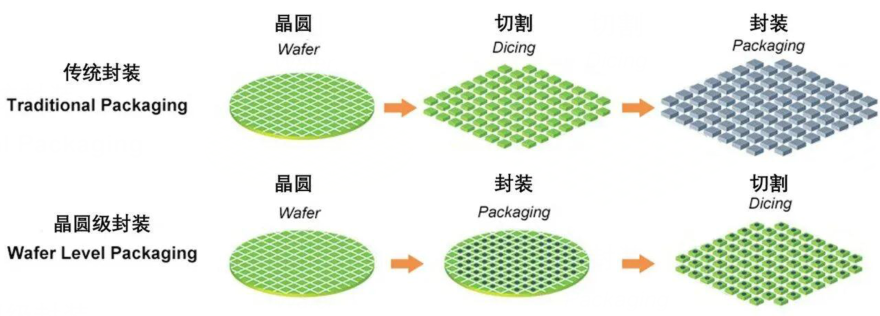
扇入型晶圆级封装(FIWLP)
扇入型WLCSP的封装布线、绝缘层和锡球直接位于晶圆顶部。
扇入型晶圆级封装优点:
1、尺寸小:封装尺寸与芯片尺寸相同,都可以将尺寸缩至最小。
2、电气特性优:锡球直接固定在芯片上,无需基板等媒介,电气传输路径相对较短,因而电气特性得到改善。
3、成本低:无需基板和导线等封装材料,工艺成本较低。这种封装工艺在晶圆上一次性完成,因而在裸片(Net Die,晶圆上的芯片)数量多且生产效率高的情况下,可进一步节约成本。
扇入型晶圆级封装缺点:
因其采用硅(Si)芯片作为封装外壳,物理和化学防护性能较弱。正是由于这个原因,这些封装的热膨胀系数与其待固定的PCB基板的热膨胀系数存在很大差异。受此影响,连接封装与PCB基板的锡球会承受更大的应力,进而削弱焊点可靠性。

扇入型晶圆级封装工艺流程:
1、从晶圆代工厂(Foundry)生产完成的晶圆(Wafer)经过测试后进入生产线。
2、为了将晶圆上的接口(I/O)引出至方便焊接的位置,在晶圆上通过金属布线工艺制作再布线层(RDL)。
3、为使芯片成品更轻薄,对晶圆进行减薄加工。
4、之后在再布线层(RDL)所连接的金属焊盘上进行植球,方便后续芯片在印刷电路板(PCB)上的焊接,最后将晶圆进行切割,以得到独立的芯片。
5、芯片产品通过最终测试后,即可出厂成为芯片成品。
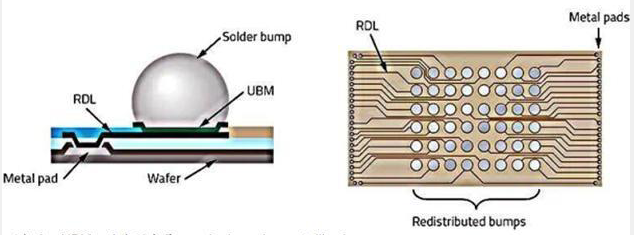
扇出型晶圆级封装(FOWLP)
扇出型晶圆级封装技术采取在芯片尺寸以外的区域做I/O接点的布线设计,提高I/O接点数量。采用RDL工艺让芯片可以使用的布线区域增加,充分利用到芯片的有效面积,达到降低成本的目的。扇出型封装技术完成芯片锡球连接后,不需要使用封装载板便可直接焊接在印刷线路板上,这样可以缩短信号传输距离,提高电学性能。
扇出型晶圆级封装优点:
1、I/O数量和密度大幅提升
FOWLP的扇出区域大大增加了焊球阵列的可布置空间,使I/O数量和密度不再受到芯片尺寸的限制。有报道称,采用FOWLP封装后,I/O数量可达到传统线束封装的2倍以上。
2、尺寸更加紧凑
标准WLP尽管体积已很小,但仍存在相当的空白区域。而通过"扇出"设计,FOWLP的封装尺寸可以缩小至芯片尺寸的1.2-1.5倍左右,未来还有进一步缩小的潜力。
3、电气特性优异
摆脱了基板和引线框架的影响,FOWLP的信号传输路径更短,寄生效应更小。同时,利用铜柱和微重布线层,器件的电流传输能力和高频特性都得到大幅提升。
4、热耗散能力强
FOWLP封装的背面能够100%暴露芯片背面,并且采用高导热环氧材料,热耗散性能出色,可大幅降低芯片的工作温度。
5、可靠性有保证
FOWLP使用的是成熟的半导体工艺,各项可靠性指标如温湿性能、热循环性能均远胜于基板类封装,是一种高质量高可靠的封装形式。
6、工艺成熟度高
FOWLP的制程有很大一部分借鉴了半导体制造工艺,因此在工艺成熟度和自动化程度方面都占有优势,也有利于降低制造成本。
7、测试质量可控
FOWLP可采用"已知良芯"(KGD)流程,即先进行芯片级测试,确保所用芯片都是合格品,从而提升产品的良率和一致性。
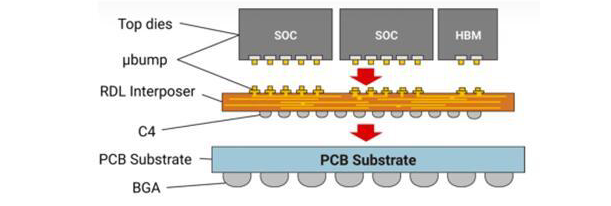
扇出型晶圆级封装工艺流程
1、从晶圆代工厂(Foundry)生产完成的晶圆(Wafer)经过测试后进入生产线类似传统封装,扇出型封装第一步也需要将来料晶圆切割成为裸晶。
2、扇出型封装的主要特点是将切割后的裸晶组合成为重构晶圆,与来料晶圆相比,重构晶圆上裸晶之间的距离相对更大,因此方便构造单位面积更大,输入输出(I/O)更多的芯片成品。
3、塑封、去除载片:完成重构晶圆的贴片后,对重构晶圆进行塑封以固定和保护裸晶。然后将重构晶圆载片移除,从而将裸晶对外的输入输出接口(I/O)露出。
4、制作再布线层:为了将裸晶上的接口(I/O)引出至方便焊接的位置,在晶圆上通过金属布线工艺制作再布线层(RDL)。
5、晶圆减薄:为使芯片成品更轻薄,对晶圆进行减薄加工。
6、植球:在再布线层(RDL)所连接的金属焊盘上进行植球,方便后续芯片在印刷电路板(PCB)上的焊接。
7、晶圆切割、芯片成品:最后将重构晶圆进行切割,以得到独立的芯片。
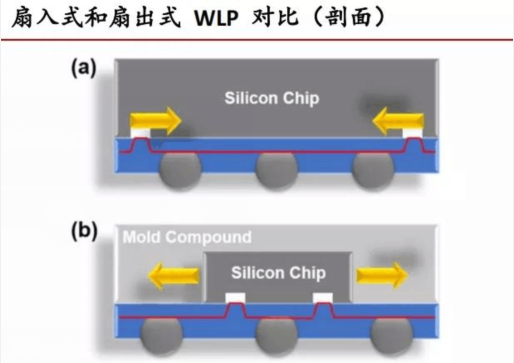
晶圆级封装清洗剂W3800介绍
晶圆级封装清洗剂W3800是针对PCBA(印刷线路板组装)焊后清洗开发的一款浓缩型环保水基清洗剂。主要用于清除电子组装件PCBA、功率LED器件及引线框架型分立器件上的锡膏或者助焊剂残留物。特别适用于助焊剂残留较多且顽固的PCBA清洗,本品在材料兼容性方面表现优越,适应于超声、喷淋等多种清洗工艺。
晶圆级封装清洗剂W3800的产品特点:
1、用去离子水按一定比例稀释后不易起泡,可以应用在在线和离线式喷淋清洗设备中。
2、清洗负载能力高,可过滤性好,具有超长的使用寿命,维护成本低。
3、适用于具有高精、高密、高洁净清洗要求的精密电子零件的清洗,特别适用于针对细间距和低底部间隙元器件的清洗应用。
4、浓缩型产品应用更宽广,选择不同的稀释比例灵活清洗不同残留。
5、对市场上大多数种类型的助焊剂和锡膏焊后残留均具有良好的清洗效果。
晶圆级封装清洗剂W3800的适用工艺:
W3800水基清洗剂适应于超声、喷淋等多种清洗工艺。
晶圆级封装清洗剂W3800产品应用:
W3800在材料兼容性方面表现优越,主要用于清除电子组装件PCBA、功率LED器件及引线框架型分立器件上的锡膏或者助焊剂残留物。特别适用于助焊剂残留较多且顽固的PCBA清洗,清洗时可根据PCBA残留物的状态,将本品按一定比例稀释后再进行使用,一般稀释比例应控制在 1:3~1:5。
具体应用效果如下列表中所列:


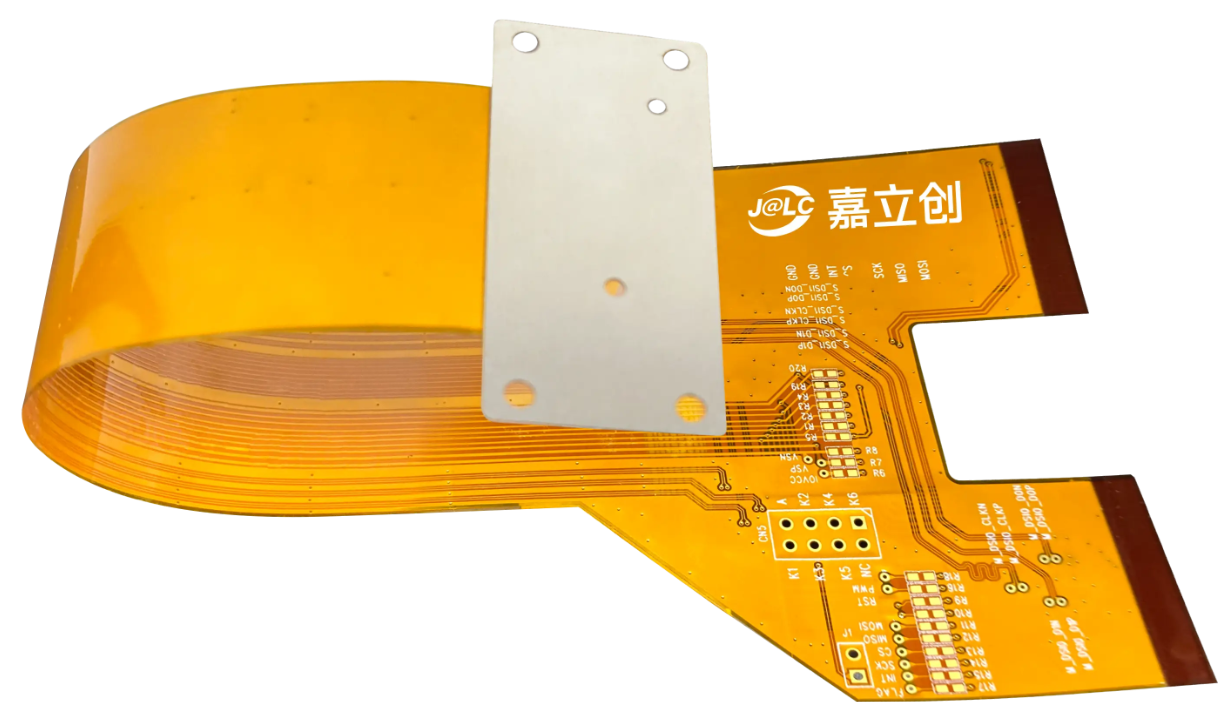



![[x]](/template/default/picture/closeimgfz1.svg)