因为专业
所以领先
封装基板的常见材料
封装基板的常见材料主要包括以下几种:
· 塑料封装基板:导热率低,可靠性差,不太适合对性能要求较高的应用。
· 金属封装基板:导热系数高,但热膨胀系数往往不匹配,价格也较高。
· 陶瓷封装基板:
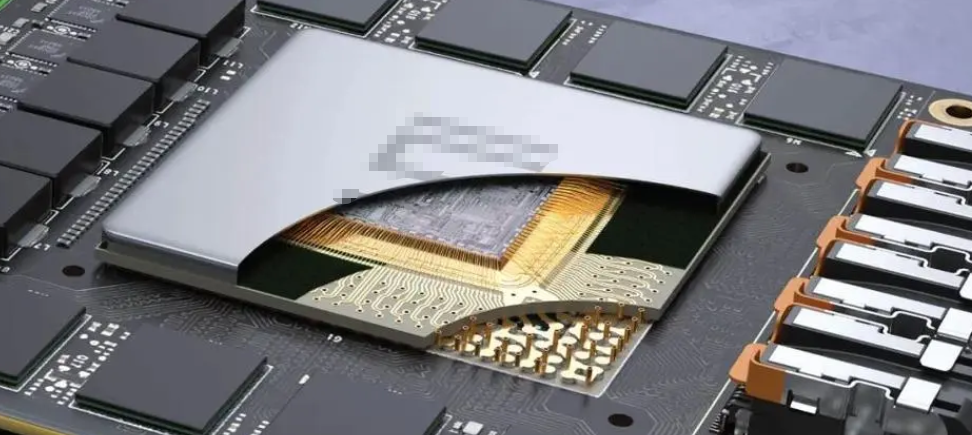
o 氧化铝陶瓷基板:原料来源丰富,成本低,机械强度和硬度高,绝缘性能好,热冲击性能好,耐化学腐蚀,尺寸精度高,与金属附着力好,是综合性能较好的陶瓷基板材料,广泛应用于电子工业,占陶瓷基板总量的 90%。
o 氮化铝陶瓷基板:具有良好的导热性、可靠的电绝缘性、低介电常数和介电损耗,与硅的热膨胀系数相匹配,是新一代高集成度半导体基板和电子封装的理想选择材料,但核心原料氮化铝粉的制备工艺复杂、能耗高、周期长、成本高。
o 氮化硅陶瓷基板:具有硬度大、强度高、热膨胀系数小、抗氧化性好、热腐蚀性能好、摩擦系数小等优良性能,与 Si、SiC、GaAs 等材料具有良好的匹配性,但介电性能较差,生产成本高。
o 碳化硅陶瓷基板:具有较高的热导率,在高温下可达 100w/(m·k)~400W/(m·k),但介电常数太高,抗压强度低,只适合低密度封装。
o 氧化铍陶瓷基板:热导率高,在高温、高频下电性能好,耐热性、耐热冲击性和化学稳定性好,但粉末具有毒性,生产成本高,限制了其生产和应用。
o 氮化硼陶瓷基板:可以以六方晶和立方晶两种形式结晶。
· 刚性基板:
o FR4:由玻璃纤维布浸渍在环氧树脂中,然后经过热压和固化处理形成的复合材料,具有阻燃性好,机械强度高,电绝缘性能优,热稳定性佳等特点。
o BT:具有高的玻璃化转变温度,较低的热膨胀系数与介电常数,良好的绝缘性等,是 BGA 封装的标准基板材料,也可用于 CSP 封装。
o ABF:是一种应用于 CPU、GPU 等高端芯片封装中的高刚性及高度耐用的材料,通常用于作为封装基板的内层绝缘材料。
· 柔性基板:
o PI(聚酰亚胺)
o PEEK(聚醚醚酮)
o PET(聚酯)
o PDMS

封装基板材料的特性
封装基板材料的特性因材料种类而异:
· 氧化铝陶瓷基板:电绝缘性能好,热导率较高,热冲击性能良好,耐化学腐蚀,尺寸精度高,与金属附着力好,但热膨胀系数和介电常数相对较高。
· 氮化铝陶瓷基板:导热性出色,电绝缘性可靠,介电常数和介电损耗低,与硅的热膨胀系数匹配良好,但制备成本高。
· 氮化硅陶瓷基板:硬度和强度高,热膨胀系数小,抗氧化和热腐蚀性能好,摩擦系数小,但介电性能较差,生产成本高。
· 碳化硅陶瓷基板:热导率高,抗氧化性能好,但介电常数高,抗压强度低。
· 氧化铍陶瓷基板:热导率高,在高温高频下电性能好,耐热性等性能良好,但粉末有毒且生产成本高。
· 氮化硼陶瓷基板:具有不同的晶体结构,特性也有所不同。
· FR4:阻燃性好,机械强度高,电绝缘性能优,热稳定性佳。
· BT:玻璃化转变温度高,热膨胀系数和介电常数低,绝缘性好。
· ABF:高刚性,耐用。

对于一般的封装基板,如 Al2O3 陶瓷,其热膨胀系数和介电常数相对 Si 单晶偏高,热导率不够高,不适合在高频、大功率、超大规模集成电路中使用;SiC 陶瓷热导率高,但介电常数高且介电强度低,只适于低密度封装;AlN 材料介电性能优良、化学性能稳定,热膨胀系数与硅较匹配,但热导率有发展瓶颈。
而金刚石作为新型半导体封装基板,热导率高达 2200~2600W/(m.K),热膨胀系数约为 1.1×10-6/℃,在半导体、光学等方面具备其他封装材料所达不到的优良特性。
封装基板的作用
封装基板主要起到以下作用:
· 为芯片提供电连接,实现芯片与外部电路的有效通信。
· 对芯片起到保护作用,防止外界环境对芯片造成损害,如物理冲击、化学腐蚀等。
· 为芯片提供支撑,确保芯片在使用过程中的稳定性。
· 帮助芯片散热,将芯片工作时产生的热量有效地传导出去,避免芯片因过热而性能下降或损坏。
· 实现芯片的多引脚化,满足复杂电路的连接需求。
· 缩小封装产品的体积,提高集成度。
· 改善电性能,如降低信号干扰、提高传输速度等。
· 实现超高密度或多芯片的模块化,便于系统的设计和组装。
不同材料对封装基板作用的影响
不同的封装基板材料因其特性的差异,对封装基板的作用产生不同的影响:
· 对于散热性能,如氧化铝陶瓷基板的热导率相对较低,而氮化铝、氮化硅、碳化硅等陶瓷基板的热导率较高,能更有效地将芯片产生的热量散发出去。
· 在电性能方面,材料的介电常数和介电损耗会影响信号传输的速度和质量,低介电常数和介电损耗的材料如氮化铝更有利于高频信号的传输。
· 热膨胀系数的匹配程度也至关重要,若基板材料与芯片的热膨胀系数不匹配,在温度变化时会产生应力,可能导致芯片损坏或连接失效。例如,氮化铝的热膨胀系数与硅较为匹配,能减少热应力的影响。
· 材料的机械强度和硬度会影响基板的支撑性能,如氮化硅陶瓷基板的硬度和强度高,能为芯片提供更稳固的支撑。
· 材料的成本和可加工性也会影响封装基板的应用范围和生产效率。
封装基板材料和作用的最新研究进展
随着电子封装技术的不断发展,封装基板材料和作用也在不断演进:
· 在材料方面,研究人员致力于开发更高性能、更低成本的封装基板材料。例如,对陶瓷基板的研究集中在提高其导热性能、降低生产成本和改善工艺;对有机基板材料的研究则注重提高其耐热性、降低介电常数等性能。
· 在作用方面,封装基板不仅要满足传统的电连接、保护、支撑和散热等功能,还需要适应更高集成度、更小尺寸、更高频率和更复杂的系统需求。例如,在 5G 通信、人工智能等领域,对封装基板的信号传输速度、散热效率和可靠性提出了更高的要求。
· 同时,新的封装技术和工艺的出现,也推动了封装基板材料和作用的创新。例如,系统级封装(SIP)技术的发展,使得封装基板需要具备更好的兼容性和多层互连能力。
· 半导体封装清洗剂W3210介绍
· 半导体封装清洗剂W3210是合明自主开发的PH中性配方的电子产品焊后残留水基清洗剂。适用于清洗PCBA等不同类型的电子组装件上的焊剂、锡膏残留,包括 SIP、WLP等封装形式的半导体器件焊剂残留。由于其 PH 中性,对敏感金属和聚合物材料有绝佳的材料兼容性。
· 半导体封装清洗剂W3210的产品特点:
· 1、PH 值呈中性,对铝、铜、镍、塑料、标签等敏感材料上显示出绝佳的材料兼容性。
· 2、用去离子水按一定比例稀释后不易起泡,可适用于喷淋、超声工艺。
· 3、不含卤素,材料环保;气味清淡,使用液无闪点,使用安全,不需要额外的防爆措施。
· 4、由于 PH 中性,减轻污水处理难度。
· 半导体封装清洗剂W3210的适用工艺:
· W3210水基清洗剂适用于在线式或批量式喷淋清洗工艺,也可应用于超声清洗工艺。
· 半导体封装清洗剂W3210产品应用:
· W3210可以应用于不同类型的焊剂残留的水基清洗剂。产品为浓缩液,清洗时可根据残留物的清洗难易程度,用去离子水稀释后再进行使用,安全环保使用方便,是电子精密清洗高端应用的理想之选。
·





![[x]](/template/default/picture/closeimgfz1.svg)