因为专业
所以领先
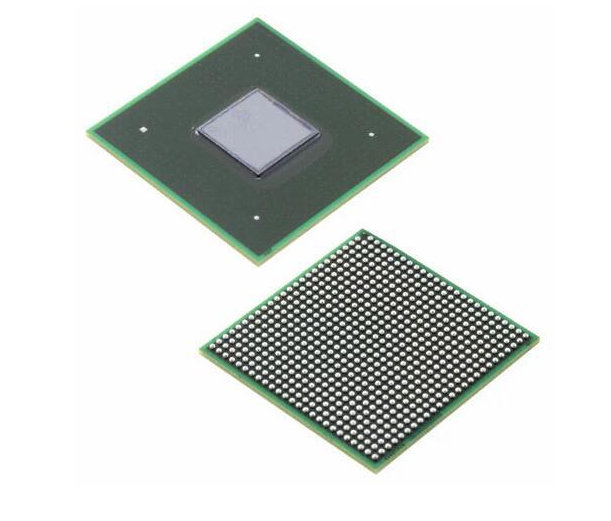
BGA 封装现已发展成为一项成熟的高密度封装技术。它的 I/O 引线以圆形或柱状焊点按阵列形式分布在封装下面,引线间距大,引线长度短,这样 BGA 消除了精细间距器件中由于引线而引起的共面性和翘曲的问题。BGA 技术的优点是可增加 I/O 数和间距,消除 QFP 技术的高 I/O 数带来的生产成本和可靠性问题。
BGA 封装主要用于高密度、高性能器件的封装,主要适用于 PC 芯片组、微处理器/控制器、ASIC、门阵列、存储器、DSP、FPGA 等器件的封装。BGA 封装按基板种类与结构可分为塑封BGA(PBGA)、陶瓷 BGA (CBGA)、陶瓷焊柱 BGA(CCGA)、载带 BGA 等。
CBGA(Ceramic Ball Grid Array,陶瓷球栅阵列)封装具有以下特点:
对湿气不敏感,可靠性好,电、热性能优良。这是因为其采用陶瓷基板,具有良好的绝缘和导热性能,能够有效保护芯片并提供稳定的电气连接。
与陶瓷基板 CTE 匹配性好。这有助于减少因热膨胀系数不匹配导致的封装失效问题。
连接芯片和元件的可返修性较好。在出现故障时,能够相对容易地进行维修和更换。
裸芯片采用 FCB 技术,互连密度更高。可以实现更多的引脚连接,提高芯片的性能和功能。
封装成本较高。由于陶瓷基板的制造工艺复杂,材料成本较高,导致整体封装成本上升。
与环氧树脂等基板 CTE 匹配性差。在与某些常见的基板材料结合使用时,可能会因热膨胀差异产生应力,影响封装的可靠性。
BGA(Ball Grid Array,球栅阵列)封装具有以下特点:
除了芯片本身,外部元件很少,没有大引脚和引出框,整个芯片在 PCB 上的高度可以做到 1.2 毫米。
引脚在底部排列整齐,利于芯片的返修,能较容易找到损坏位置进行拆除。
信号环路小,在相等引脚数目的条件下,BGA 封装环路通常是 QFP 或者 SOIC 的 1/2 到 1/3,辐射噪声小,管脚之间的串扰也变小。
可以高效地设计出电源和地引脚的分布情况,地弹效应使得电源和地引脚数量不断减少。
封装很牢靠,同 20mil 间距的 QFP 相比,BGA 没有可以弯曲和折断的引脚。
可以把很多的电源和地引脚放在中间,I/O 口的引线放在外围,可预先布线,避免 I/O 口走线混乱。
高级 BGA 封装,可以把所有的引脚都正好放置在芯片下面,不会超过芯片的封装,有利于微型化。
焊盘相对较大,在操作返修的时候易于操作。
不需要更高级的 PCB 工艺,有足够的机制来保证硅片上热量的压力。
本身很小的封装,有很好的散热属性,大多数热量可以向下传播到 BGA 的球阵列上,如果硅片是贴在底面的话,那么硅片的背部是和封装的顶部相连接,这是很合理的散热方法。

BGA 封装的类型多种多样,根据基板的不同,主要分为三类:PBGA(Plastic Ball Grid Array 塑料焊球阵列)、CBGA(Ceramic Ball Grid Array 陶瓷焊球阵列)、TBGA(Tape Ball Grid Array 载带型焊球阵列)。
PBGA 采用 BT 树脂/玻璃层压板作为基板,以塑料作为密封材料,焊球为共晶焊料 63Sn37Pb 或准共晶焊料 62Sn36Pb2Ag,焊球和封装体的连接不需要另外使用焊料。
CBGA 的基板是多层陶瓷,金属盖板用密封焊料焊接在基板上,用以保护芯片、引线及焊盘。焊球材料为高温共晶焊料 10Sn90Pb,焊球和封装体的连接需使用低温共晶焊料 63Sn37Pb。
CBGA 具有良好的抗湿气性能、电绝缘特性和散热性能,但与 PCB 的热匹配性差,焊点疲劳是主要的失效形式,且封装成本高。
BGA 器件对于贴装精度的要求不太严格,在焊接回流过程中,即使焊球相对于焊盘的偏移量达 50%之多,也会由于焊料的表面张力作用而使器件位置得以自动校正。BGA 不再存在类似 QFP 之类器件的引脚变形问题,而且 BGA 还具有相对 QFP 等器件较良好的共面性,其引出端间距与 QFP 相比要大得多,可以明显减少因焊膏印刷缺陷导致焊点“桥接”的问题。另外,BGA 还有良好的电性能和热特性,以及较高的互联密度。但 BGA 的主要缺点在于焊点的检测和返修都比较困难,对焊点的可靠性要求比较严格,使得 BGA 器件在很多领域的应用中受到限制。
BGA 封装类型众多,不同类型的 BGA 封装在应用场景上有所不同。
PBGA 由于制作成本低,性价比高,与环氧树脂基板热匹配性好,常用于一些对成本较为敏感,对性能要求不是特别高的电子产品中。
CBGA 因其良好的电、热性能和可靠性,常用于对可靠性要求较高,工作环境较为恶劣的电子产品,如航空航天、军事等领域。但由于其成本较高,在一般消费类电子产品中的应用相对较少。

芯片封装清洗剂W3210介绍
· 半导体芯片封装清洗剂W3210是合明自主开发的PH中性配方的电子产品焊后残留水基清洗剂。适用于清洗PCBA等不同类型的电子组装件上的焊剂、锡膏残留,包括 SIP、WLP等封装形式的半导体器件焊剂残留。由于其 PH 中性,对敏感金属和聚合物材料有绝佳的材料兼容性。
· 半导体芯片封装清洗剂W3210的产品特点:
· 1、PH 值呈中性,对铝、铜、镍、塑料、标签等敏感材料上显示出绝佳的材料兼容性。
· 2、用去离子水按一定比例稀释后不易起泡,可适用于喷淋、超声工艺。
· 3、不含卤素,材料环保;气味清淡,使用液无闪点,使用安全,不需要额外的防爆措施。
· 4、由于 PH 中性,减轻污水处理难度。
· 半导体封装清洗剂W3210的适用工艺:
· W3210水基清洗剂适用于在线式或批量式喷淋清洗工艺,也可应用于超声清洗工艺。
· 半导体封装清洗剂W3210产品应用:
· W3210可以应用于不同类型的焊剂残留的水基清洗剂。产品为浓缩液,清洗时可根据残留物的清洗难易程度,用去离子水稀释后再进行使用,安全环保使用方便,是电子精密清洗高端应用的理想之选。





![[x]](/template/default/picture/closeimgfz1.svg)