因为专业
所以领先
FCBGA(Flip Chip Ball Grid Array)倒装芯片封装是一种先进的芯片封装技术,它在现代电子制造领域有着广泛的应用。
倒装芯片技术与传统的芯片封装技术有所不同。传统封装中,裸片和载体之间的互连使用导线制成,而倒装芯片封装中的管芯和载体之间的互连通过直接放置在管芯表面上的导电“凸点”来实现。在FCBGA封装过程中,芯片被倒置安装在基板上,然后用焊球将芯片连接到基板上,这种方式可以减小信号电感,提高信号密度,缩小晶片尺寸和封装面积等优势 。
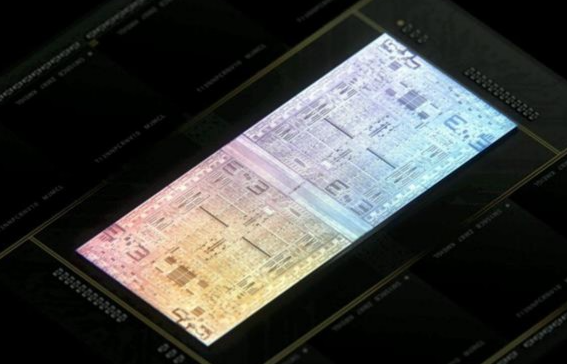
FCBGA倒装芯片的工艺流程是一个较为复杂的过程,涉及多个步骤。首先是准备工作,包括准备封装材料、制定工艺流程和准备封装设备等。接着是芯片加工,这一步可能涉及到在芯片上制作凸点等操作。然后是封装过程,包括将芯片倒装并连接到基板上,以及后续的一些处理。最后是测试环节,以确保封装后的芯片能够正常工作 。
材料选择与清洁
基板通常由介电材料制成,如FR - 4或聚酰亚胺。在进行后续步骤之前,必须对基板进行清洁处理,以确保基板与铜层之间能够有良好的粘合。这是因为如果基板表面存在杂质或者污染物,可能会影响到后续的布线、连接等工序,从而影响整个封装的质量和性能 。
布线与设计
根据芯片的功能和封装要求,在基板上进行布线设计。FCBGA基板需要具备高密度的布线结构,以满足芯片高速化与多功能化的需求。例如,一些高端数字芯片,如人工智能、5G、大数据、高性能计算、智能汽车和数据中心等应用中的CPU、图形处理器(GPU)、FPGA等,需要FCBGA基板提供复杂而精确的电气互连线路,以实现信号的快速传输和处理 。
凸点材料选择
凸点的制作是FCBGA倒装芯片工艺中的关键步骤之一。凸点通常为60 - 100μm高,直径为80 - 125μm。目前,凸点的材料选择主要有共晶Sn/Pb、无铅(98.2%Sn,1.8%Ag)或Cu柱组成。不同的材料具有不同的物理和化学性质,例如,无铅材料的使用是为了满足环保要求,同时在焊接性能和可靠性方面也有较好的表现 。
制作工艺
凸点的制作工艺可以通过多种方法实现,例如电镀、化学镀等。这些方法可以精确地控制凸点的形状、大小和高度等参数。在制作过程中,需要确保凸点与芯片的I/O焊盘之间有良好的电气连接,并且凸点的分布要均匀,以保证在倒装焊接时能够与基板上的对应位置准确连接。

拾取芯片
使用专门的设备将制作好凸点的芯片从晶圆上拾取出来。这个过程需要精确的定位和操作,以避免对芯片造成损坏。例如,一些高精度的拾取设备可以通过真空吸附等方式,轻柔地将芯片从晶圆上分离出来,并且能够准确地将芯片移动到下一个工序的操作位置。
印刷焊膏或导电胶
在基板上需要焊接芯片的位置印刷焊膏或导电胶。焊膏或导电胶的作用是在芯片倒装焊接时提供良好的电气连接和机械固定。如果使用焊膏,其成分和性能需要根据凸点的材料和焊接工艺进行选择。例如,对于无铅凸点,需要使用与之匹配的无铅焊膏,以确保焊接的质量和可靠性。
倒装焊接(贴放芯片)
将拾取的芯片翻转并准确地贴放到基板上印刷有焊膏或导电胶的位置。这个过程需要极高的精度,因为芯片上的凸点必须与基板上的相应焊点精确对准。通常采用高精度的贴片机来完成这一操作,贴片机可以通过视觉识别系统来定位芯片和基板上的对准标记,从而实现准确的贴放。
再流焊或热固化(或紫外固化)
如果使用焊膏进行焊接,则需要进行再流焊工艺。再流焊是将印刷有焊膏的芯片和基板加热到焊膏的熔点以上,使焊膏熔化并在凸点和基板焊点之间形成良好的电气连接。对于使用导电胶的情况,则需要进行热固化或紫外固化,使导电胶固化并实现芯片与基板的连接。再流焊或固化过程中的温度曲线控制非常关键,不同的材料和工艺要求有不同的温度曲线,以确保焊接或固化的质量,避免出现虚焊、短路等缺陷。
底部填充材料选择
在芯片焊接完成后,需要在芯片和基板之间加入底部填充物。底部填充物是一种专门设计的环氧树脂,其主要作用是填充芯片和载体之间的区域,围绕焊料凸块。这种材料的选择要考虑到与芯片、基板和焊料等材料的兼容性,以及其对热膨胀系数的调节能力。例如,底部填充物需要能够在不同的温度环境下保持稳定的性能,以防止由于硅晶片和载体之间的热膨胀差引起的焊点应力过大而导致的焊点失效。
填充工艺
底部填充的工艺通常采用注射的方式,将液态的底部填充材料注入到芯片和基板之间的间隙中。在注入过程中,要确保填充材料能够均匀地分布在整个间隙中,避免出现气泡、空洞等缺陷。填充完成后,需要进行固化处理,使底部填充材料固化,从而实现其对焊点应力的吸收和分散功能。
电气性能测试
对封装后的芯片进行电气性能测试,包括测试芯片的电路连接是否正常、信号传输是否正确等。例如,可以使用测试设备对芯片的各个引脚进行电气参数测量,如电阻、电容、电感等参数的测量,以及信号的输入输出测试,以确保芯片能够按照设计要求正常工作。
可靠性测试
进行可靠性测试,以评估封装后的芯片在不同环境条件下的稳定性和可靠性。这包括高温、低温、湿度、振动等环境条件下的测试。例如,在高温测试中,将芯片放置在高温环境箱中,观察芯片在高温下的性能变化,检查是否会出现电路短路、开路或者性能下降等问题;在湿度测试中,模拟高湿度环境,检测芯片是否会因为受潮而出现腐蚀、漏电等故障。
尺寸精度
凸点的尺寸精度直接影响到芯片与基板的连接质量。如果凸点的高度或直径不符合要求,可能会导致在倒装焊接时凸点与基板焊点之间的接触不良。例如,凸点过高可能会造成焊接不完全,凸点过低则可能无法与焊点充分接触,从而影响电气连接的可靠性。因此,在凸点制作过程中,需要采用高精度的工艺设备和严格的工艺控制,确保凸点的尺寸在规定的误差范围内。
材料特性与一致性
凸点材料的特性对整个封装的性能也有重要影响。如前所述,不同的材料如共晶Sn/Pb、无铅(98.2%Sn,1.8%Ag)或Cu柱等,其熔点、导电性、热膨胀系数等特性各不相同。在生产过程中,要保证凸点材料的一致性,即同一批次的凸点材料在物理和化学性质上要保持一致,否则可能会导致在焊接过程中出现不同的焊接效果,影响封装的质量和可靠性。
视觉识别与定位系统
在芯片倒装焊接过程中,芯片上的凸点与基板上的焊点必须精确对准。为了实现这一目标,通常采用高精度的视觉识别与定位系统。这个系统能够识别芯片和基板上的对准标记,然后通过控制系统调整芯片的位置,使其准确地贴放到基板上。例如,视觉识别系统可以通过摄像头拍摄芯片和基板的图像,然后利用图像处理算法分析图像中的对准标记位置,将其转换为实际的坐标信息,以供贴片机进行准确的定位操作。
设备精度与稳定性
用于芯片倒装焊接的设备(如贴片机)的精度和稳定性也是关键因素。设备的精度决定了其能够实现的最小对准误差,而设备的稳定性则确保在长时间的生产过程中能够保持一致的对准精度。例如,一些高端的贴片机设备具有亚微米级的对准精度,并且能够在长时间连续工作的情况下保持稳定的性能,这对于大规模生产高质量的FCBGA倒装芯片至关重要。
填充均匀性
底部填充材料在芯片和基板之间的填充均匀性是底部填充质量的关键指标之一。如果填充不均匀,可能会在芯片和基板之间形成气泡或空洞。这些缺陷会影响底部填充材料对焊点应力的吸收和分散功能,从而降低封装的可靠性。为了确保填充均匀性,在填充过程中需要优化注射工艺参数,如注射速度、注射压力、注射角度等,同时还要对填充过程进行实时监控,及时发现并纠正可能出现的不均匀现象。
与其他材料的兼容性
底部填充材料需要与芯片、基板和焊料等材料具有良好的兼容性。如果兼容性不好,可能会出现化学反应、分层等问题。例如,底部填充材料与焊料之间可能会发生化学反应,导致焊点的腐蚀或者电气性能下降;与芯片或基板材料的不兼容可能会引起分层现象,使芯片与基板之间的连接松动,影响整个封装的机械和电气性能。因此,在选择底部填充材料时,需要进行充分的材料兼容性测试。
温度曲线优化
在再流焊、热固化或紫外固化等涉及到温度控制的工艺环节中,优化温度曲线是提高封装质量的重要方法。例如,对于再流焊工艺,通过精确调整预热温度、升温速率、峰值温度、回流时间和冷却速率等参数,可以使焊膏在最佳的温度条件下熔化和凝固,从而获得良好的焊接质量。不同的焊膏材料和芯片、基板的组合可能需要不同的温度曲线,因此需要根据具体情况进行优化实验,找到最适合的温度曲线。
压力和时间参数优化
在芯片倒装焊接和底部填充等过程中,压力和时间参数也会影响封装质量。在倒装焊接时,适当的压力可以确保芯片与基板之间的良好接触,但压力过大可能会损坏芯片或基板。同样,在底部填充过程中,注射压力和填充时间需要合理设置,以保证填充的均匀性和完整性。通过实验和模拟分析等手段,可以确定最佳的压力和时间参数,提高封装的成功率和质量。
提高设备精度
如前所述,在FCBGA倒装芯片工艺中,设备的精度对于凸点制作、芯片倒装焊接和底部填充等环节至关重要。通过改进设备的机械结构、采用更高精度的传感器和控制系统等方式,可以提高设备的精度。例如,对于贴片机,可以采用更精密的运动平台和定位机构,以及更高分辨率的视觉识别传感器,从而提高芯片倒装焊接的对准精度。
提高设备自动化程度
提高设备的自动化程度可以减少人为因素对封装质量的影响,提高生产效率。例如,在芯片拾取、焊接、填充等工序中,可以采用自动化的设备和机器人操作,实现全自动化的生产流程。自动化设备可以按照预设的程序精确地执行各项操作,并且可以实现实时监控和反馈,一旦出现异常情况可以及时进行调整,保证生产的连续性和稳定性。
新型凸点材料研发
研发新型的凸点材料可以提高凸点的性能和可靠性。例如,寻找具有更低熔点、更好导电性和热稳定性的凸点材料,可以改善焊接效果和降低功耗。同时,新型凸点材料还可以提高与其他材料的兼容性,减少在封装过程中的化学反应和应力问题。
底部填充材料性能提升
改进底部填充材料的性能也是流程优化的一个方向。例如,开发具有更高热导率的底部填充材料,可以提高芯片的散热性能;研制具有更好的抗热膨胀性能的底部填充材料,可以更有效地吸收和分散焊点应力,提高封装的可靠性。
满足高性能需求
以服务器、人工智能和网络设备用高端处理器为例,这些处理器对芯片的封装有极高的要求。FCBGA倒装芯片工艺能够满足其高性能需求,主要体现在以下几个方面。首先,通过倒装芯片的短互连结构,可以减小信号电感,提高信号传输速度,满足高端处理器高速数据处理的要求。其次,FCBGA基板的高密度布线结构可以为处理器提供大量的电气互连线路,支持其复杂的功能逻辑。例如,在人工智能处理器中,需要大量的信号传输线路来实现神经网络算法的运算,FCBGA封装能够有效地实现这些信号的传输和处理 。
可靠性保障
在高端处理器的工作环境中,温度、湿度等环境因素的变化较大。FCBGA倒装芯片工艺中的底部填充环节能够有效地提高封装的可靠性。底部填充材料可以吸收由于硅晶片和载体之间的热膨胀差引起的焊点应力,防止焊点在温度变化时出现开裂等故障。同时,在高湿度环境下,FCBGA封装的密封性和防护性能也能够保护芯片免受潮气的侵蚀,保证处理器的稳定运行。
适应恶劣环境
在汽车电子领域,如发动机控制单元、车载信息娱乐系统等部件中的芯片需要适应恶劣的工作环境。FCBGA倒装芯片工艺能够满足汽车电子的要求。例如,在汽车行驶过程中,会产生振动、冲击等机械应力,FCBGA封装的牢固结构可以保证芯片在这些机械应力下不会松动或损坏。而且,汽车的工作温度范围较宽,从低温的寒冷环境到高温的发动机舱环境,FCBGA倒装芯片的材料选择和封装结构能够适应这种宽温度范围的变化,确保芯片的正常工作。
满足安全与可靠性要求
汽车电子芯片的安全性和可靠性至关重要。FCBGA倒装芯片工艺通过严格的质量控制和可靠性测试,可以保证芯片在汽车电子系统中的安全可靠运行。例如,在汽车安全系统中的芯片,如制动系统、安全气囊系统等,必须保证在任何情况下都能正常工作。FCBGA封装的高质量焊接和底部填充等工艺环节能够提高芯片的抗干扰能力和稳定性,防止因为芯片故障而导致的安全事故。
互连方式
传统芯片封装工艺中,裸片和载体之间的互连使用导线制成,而FCBGA倒装芯片封装通过在管芯表面的导电“凸点”实现互连。这种凸点互连方式相比于传统的导线互连具有明显的优势。例如,凸点互连的长度更短,能够显著减小信号电感,这对于高速通讯和信号处理的芯片非常重要。在传统的导线互连中,电线长度通常为1 - 5毫米,而倒装芯片的凸点互连长度可以缩短至0.1毫米左右,大大提高了信号传输的速度和质量 。
封装尺寸与密度
FCBGA倒装芯片封装能够实现更小的封装尺寸和更高的封装密度。由于凸点互连不需要像导线互连那样占用较大的空间,并且FCBGA基板可以采用高密度布线结构,所以可以在更小的面积内容纳更多的芯片功能。相比之下,传统封装方式由于导线的存在,限制了封装的密度提升,并且需要更大的封装面积来实现相同的功能。
性能表现
在性能方面,FCBGA倒装芯片封装在信号完整性、电源完整性等方面表现更优。例如,由于凸点互连减小了信号电感,信号的完整性得到了提高,减少了信号的衰减和失真。在电源完整性方面,倒装芯片互连可以使电源能够直接连接至晶片核心,而不是像传统封装那样需要重新布线至边缘,从而减少了电源/接地电感,提高了电源的供应效率和稳定性。
焊接材料与工艺
在FCBGA倒装芯片工艺中,存在不同的焊接材料和工艺选择。例如,焊接材料可以选择共晶Sn/Pb、无铅(98.2%Sn,1.8%Ag)或Cu柱等。不同的焊接材料具有不同的熔点、导电性和热膨胀系数等特性,因此在焊接工艺上也会有所不同。共晶Sn/Pb材料的焊接工艺相对成熟,但由于含铅不符合环保要求,逐渐被无铅材料所替代。无铅(98.2%Sn,1.8%Ag)材料的焊接需要调整温度曲线等工艺参数,以确保良好的焊接效果。Cu柱焊接则具有一些特殊的工艺要求,如在焊接时需要更高的压力和温度控制精度。
底部填充工艺差异
底部填充工艺也可能存在差异。不同的底部填充材料在填充方式、固化条件等方面可能不同。例如,一些底部填充材料可能采用热固化方式

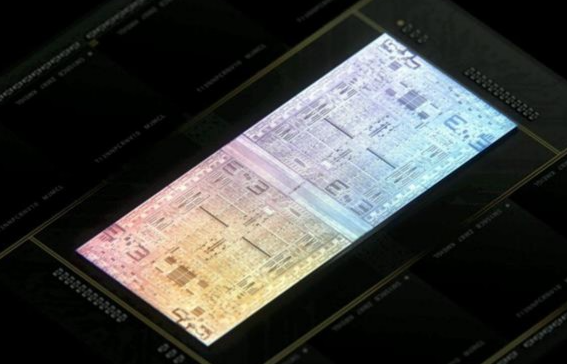



![[x]](/template/default/picture/closeimgfz1.svg)