因为专业
所以领先
半导体制造材料(2)-光刻胶
光刻胶(Photoresist)又称光致抗蚀剂,是指通过紫外光、电子束、离子束、X射线等的照射或辐射,其溶解度发生变化的耐蚀剂刻薄膜材料。光刻胶是由感光树脂、增感剂和溶剂3种主要成分组成的对光敏感的混合液体。光刻胶是微电子领域之中的一个细图加工最主要的工具,光刻胶在光刻工艺过程中,用作抗腐蚀涂层材料。近年来经济快速发展,芯片,集成电路等行业都得到了极大的发展,而光刻胶作为这些行业的下游产业链,同样的迎来了自己的发展。光刻是半导体前道制程中的关键工艺,光刻工艺能够实现的精度与其中所使用的设备-光刻机、材料-光刻胶紧密相关。光刻胶主要应用于显示面板、集成电路和半导体分立器件等细微图形加工作业。光刻胶生产技术较为复杂,品种规格也较多。
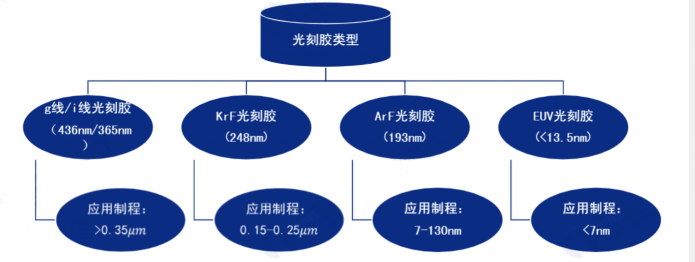
一、光刻原理:
光刻胶在半导体制程中起到了图形转移的作用。光刻工艺中,在待刻蚀物质的表面涂敷光刻胶,光刻胶经曝光后,被曝光部分或者未曝光部分在显影过程中被去除,从而得到所需要的图形,在此基础上对物质进行针对性的刻蚀,最后去除掉光刻胶。在实际工艺中,为达到更好的光刻效果,会在曝光前后以及显影后对光刻胶进行烘焙。
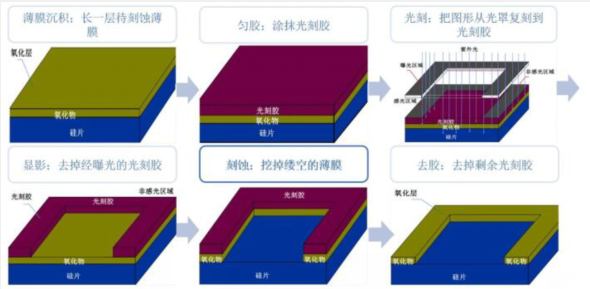
二、光刻胶分类:
根据应用领域,光刻胶可分为半导体光刻胶、平板显示光刻胶和PCB光刻胶,其技术壁垒依次降低。相应地,PCB光刻胶是目前国产替代进度最快的,显示光刻胶替代进度相对较快,半导体光刻胶目前国产技术较国外先进技术差距最大。
PCB光刻胶用于印刷线路板的图案化工艺,主要分为干膜光刻胶、湿膜光刻胶、阻焊油墨。干膜光刻胶是由配置好的液态光刻胶均匀涂抹在载体PET薄膜上,经过烘干、冷却后,盖上PE薄膜,收卷而成的薄膜光刻胶。在使用时,将干膜光刻胶压在覆铜板上,经过曝光显影将电路图转移到光刻胶上。通过后续对覆铜板刻蚀加工,形成PCB上的线路,主要用于75-100μm制程。湿膜光刻胶又称为感光线路油墨,分为抗电镀油墨和抗刻蚀油墨,与干膜工序相似,材料成本比干膜要低,但是加工设备成本较高,主要用于25-75μm制程。阻焊油墨用于在线路上形成永久的绝缘保护层,防止在焊锡过程中的短路,保证PCB在运输、存放、使用时安全性。进一步可以细分为UV固化阻焊油墨和液态感光阻焊油墨。前者用在对精度要求不高的PCB上,附着力较差;感光阻焊油墨则精密度较高。
显示光刻胶用于平板显示、显示器、LCD彩色滤波片制作等光刻工艺中,使用的光刻胶品种根据应用工艺不同主要分为TFT-Array光刻胶、彩色和黑色光刻胶等。TFT-Array正性光刻胶主要应用于TFT-LCD或AMOLED制造中的Array段,包括TFT的图案化光刻胶,保护绝缘层光刻胶,ITO图案化光刻胶,OLED Array中平坦层光刻胶,OLED中PDL像素层光刻胶和Yocta制程光刻胶。彩色滤光片由玻璃基板、黑色矩阵、颜色层、保护层、ITO导电层等构成,用于实现LCD面板的彩色显示,彩色光刻胶(RGB)分为红、绿、蓝三原色光刻胶,经过涂抹、曝光、显影等工序组成了颜色层;黑色光刻胶则用于形成黑色矩阵(Black Matrix),起到防止漏光的作用。
根据曝光波长的不同,目前市场上应用较多的半导体光刻胶可分为g线、i线、KrF、ArF和EUV 5 种类型。光刻胶波长越短,加工分辨率越高,不同的集成电路工艺在光刻中对应使用不同波长的光源。随着芯片制程的不断进步,每一代新的光刻工艺都需要新一代的光刻胶技术与之相匹配。g/i 线光刻胶诞生于 20 世纪 80 年代,当时主流制程工艺在 0.8-1.2μm,适用于波长 436nm 的光刻光源。到了 90 年代,制程进步到 0.35-0.5μm,对应波长更短的 365nm 光源。当制程发展到 0.35μm 以下时,g/i 线光刻胶已经无法制程工艺的需求,于是出现了适用于 248nm波长光源的 KrF 光刻胶,以及193 纳米波长光源的 ArF光刻胶,两者均是深紫外光刻胶。EUV(极紫外光)是目前最先进的光刻胶技术,适用波长为13.5nm的紫外光,可用于10nm以下的先进制程,目前仅有ASML集团掌握EUV光刻胶所对应的光刻机技术。
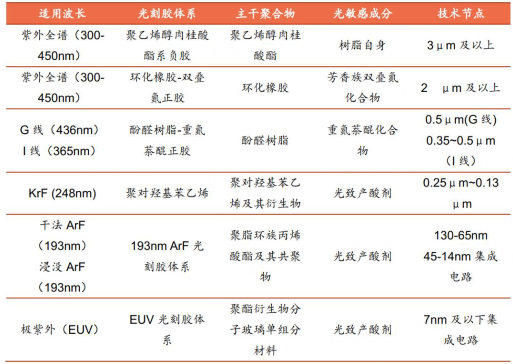
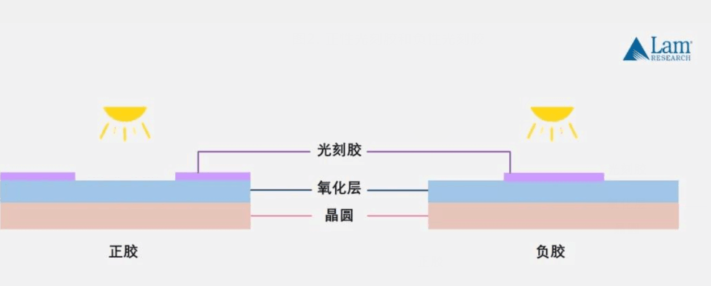
根据在曝光时的光化学反应过程的不同,光刻胶可以分为光聚合型、光分解型、光交联型和化学放大四种类型。光聚合型是最为初级的材料类型,通过烯类单体在光作用下可产生自由基,生成聚化物的特性,常用于制造正型光刻胶。光分解型光刻胶采用含有重氮醌类化合物材料作为感光剂,光线照射后发生光分解反应,由油性变为水性溶剂,可制造正性光刻胶。光交联型光刻胶采用聚乙烯醇月桂酸酯作为光敏材料,光线照射后形成一种网状结构的不溶物,可起到抗蚀作用,适用于制成负性光刻胶。化学放大型光刻胶使用光致酸剂作为光引发剂,光线照射后,曝光区域的光致酸剂会产生一种酸,并在后热烘培工序期间作为催化剂移除树脂的保护基团,使树脂变得可溶。化学放大光刻胶对深紫外光源具有良好的光敏性,具有高对比度、分辨率等优点。

以上是关于半导体制造材料(2)-光刻胶的相关内容介绍了,希望能对您有所帮助!
想要了解关于芯片半导体清洗的相关内容,请访问我们的“半导体封装清洗”专题了解相关产品与应用 !
是一家电子水基清洗剂 环保清洗剂生产厂家,其产品覆盖半导体清洗 芯片清洗等电子加工过程整个领域。欢迎使用 水基清洗剂产品!
上一篇:半导体制造材料(1)-溅射靶材





![[x]](/template/default/picture/closeimgfz1.svg)