因为专业
所以领先
半导体制造设备系列(1)-光刻机
光刻机当前对我国的战略意义,似乎不亚于多半个世纪前原子弹的战略意义。以至于网络上出现了诸多类似于“光刻机和原子弹哪个更难造”的讨论。半导体工艺推动了现代社会的科技进步,而光刻机则是半导体工业中的“皇冠”。
一、光刻机的原理:
光刻是指光刻胶在特殊波长光线或者电子束的作用下发生化学变化,通过后续曝光、显影、刻蚀等工艺过程,将设计在掩膜版上的图形转移到衬底上的图形精细加工技术。激光器作为光源发射光束,经过光路调整后,光束穿透掩膜版及镜片,经物镜补偿光学误差,将图形曝光在带有光刻胶的硅晶圆上,然后显影在硅片上。
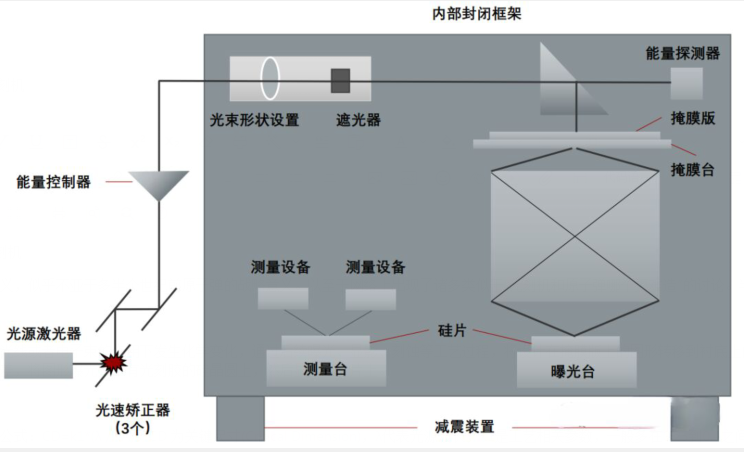
图1. 光刻机结构示意图
光刻行业的关键定理—瑞利公式:CD=k1*(λ /NA)。CD 为关键尺寸(Critical Dimension),λ代表光源波长;k1是工艺相关参数,一般多在0.25到0.4之间;NA(Numerical Aperture)被称作数值孔径,是光学镜头的一个重要指标,一般光刻机设备都会明确标注该指标的数值。为了降低 CD,实现更为精细的加工尺寸,有三种方式:(1) 降低光源的波长λ;(2) 提高镜头的数值孔径 NA;(3) 降低综合因素 k1。
光刻机的另外一个重要参数是套刻精度(Overlay Accuracy)。其基本含义是指前后两道光刻工序之间彼此图形的对准精度(3σ),如果对准的偏差过大,就会直接影响产品的良率。对于高阶的光刻机,一般设备供应商就套刻精度会提供两个数值,一种是单机自身的两次套刻误差,另一种是两台设备(不同设备)间的套刻误差。
二、光刻机的分类:
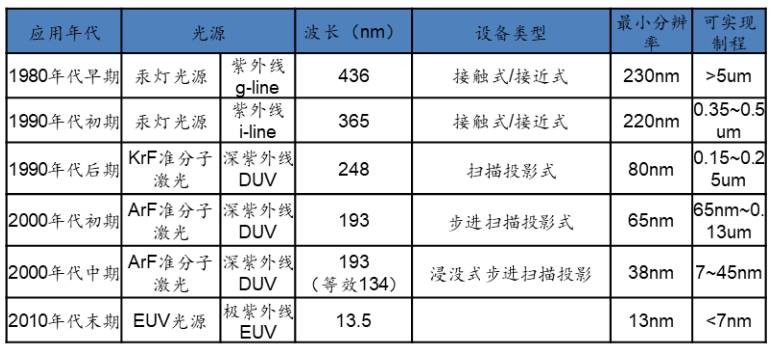
图2. 光刻机发展历程
光刻机发展至今,已经历了5代产品的迭代。在1985年之前,第一代光刻机光源以436nm的g-line汞灯光源为主,只适用于5μm以上制程;之后出现了365nm的i-line汞灯光源的第二代光刻机,制程精度来到了350-500nm。第一二代均为接触/接近式光刻机。第三代为扫描投影式光刻机,光源改进为248nm的KrF氟化氪准分子深紫外光源(DUV:Deep Ultraviolet Light),实现了跨越式发展,将最小工艺推进至150-250nm;第四代为步进式投影式光刻机,采用193nm波长的ArF氟化氩准分子激光光源,可实现制程推进到了65-130nm,在此基础上又实现了浸入步进式投影式光刻机(ArFi光刻, i代表immersion):所谓浸入技术,就是让镜头和硅片之间的空间浸泡于液体之中。由于液体的折射率大于1,使得激光的实际波长会大幅度缩小。目前主流采用的纯净水的折射率为1.44,所以ArF加浸入技术实际等效波长=193nm/1.44=134nm,从而实现更高的分辨率。
按照这个发展思路,那么下面应该就是采用波长更短的准分子激光器,实现更高分辨率。基于F2(氟)准分子激光器成为了潜在选手,其波长为157nm。然而F2准分子激光器在叠加浸入式的时候出现了问题,由于在157nm波长下水是不透明的液体,无法通过浸入式来进一步降低波长,因此需要寻找新的发展方向。第五代为EUV(Extreme Ultraviolet, 极紫外)光刻机,选取了新的方案来进一步提供更短波长的光源。目前主要采用的办法是将准分子激光照射在锡等靶材上,激发出13.5nm的光子,作为光刻机光源。ASML 目前其是全世界唯一一家能够设计和制造EUV光刻机设备的厂商。
三、光刻机的产业链:
光刻机产业链主要包括上游核心组件及配套设备、中游光刻机生产及下游光刻机应用三大环节。光刻机技术极为复杂,在所有半导体制造设备中技术含量最高。主要涉及系统集成、精密光学、精密运动、精密物料传输、高精度微环境控制等多项先进技术, 生产一台光刻机往往涉及到上千家供应商,比如德国的光学设备与超精密仪器,美国的计量设备与光源等, 主要组件包括双工作台、 光源系统、 曝光系统、浸没系统、 物镜系统、光栅系统等,配套设施包括光刻胶、掩膜版、涂胶显影等。

图3. 光刻机产业链
光刻机中最核心组件是光源和镜头。以ASML为例,其镜头供应商为德国蔡司,光源供应商为美国 Cymer(已被ASML收购)和日本 Gigaphoton,其中 EUV 光刻机光源由 Cymer 独家供应。
镜头:当波长达到EUV波段时,绝大多数材料都不具有良好的透射特性,DUV类似的透射光学系统将不再适用。因此EUV及以后的更短波长光刻机基本都只能做反射系统。然而,现实世界中没有任何材料可以在单层中反射大部分 EUV 光。然而多层则可以增强彼此的反射,于是业界探讨用这种方式制作相当高效的 EUV 反射镜来缩小和聚焦图像。而由钼(部分反射 EUV 光)和硅(对 EUV 大部分透明)交替纳米层制成的反射镜就成为了大家努力的方向。不过,这样的EUV 反射镜的制作极其复杂,因为它们的表面需要几乎完美光滑和干净,每个纳米层都需要具有精确定义的厚度。让每个原子都需要在正确的位置,否则可能会丢失光或图像可能会变形。
光源: 所谓EUV极紫外光,是指波长在10-100nm范围内的紫外线。然而,地球上是没有自然的EUV光源的,太阳光谱中的EUV部分会被大气层和臭氧层完全吸收,无法到达地面,因此需要人工产生EUV。人工产生EUV主要有2个难点:首先,EUV 光很难以受控方式产生。只有多重电离原子内壳中的激发电子才能发射 EUV。其次,EUV 光很容易被空气和其他气体吸收。这意味着光从产生的那一刻到撞击硅片的那一刻,都必须穿过高质量的真空。这也意味着不可能构建“EUV 镜头”。相反,需要使用高度复杂的曲面反射镜。传统的光掩模也会吸收过多的光,因此它也需要具有反射性。

图4. ASML、Nikon、Canon光刻机销售情况
以上是关于半导体制造设备系列(1)-光刻机的相关内容介绍了,希望能对您有所帮助!
想要了解关于芯片半导体清洗的相关内容,请访问我们的“半导体封装清洗”专题了解相关产品与应用 !
是一家电子水基清洗剂 环保清洗剂生产厂家,其产品覆盖半导体清洗 芯片清洗等电子加工过程整个领域。欢迎使用 水基清洗剂产品!





![[x]](/template/default/picture/closeimgfz1.svg)