因为专业
所以领先
针对半导体封装结构,可通过计算机模拟的方式去分析。通常情况下,计算机模拟分析过程会将推导出的一般方程应用于特定条件中,以便深入了解特定情况。标准的计算机模拟分析过程包括四个步骤。
首先,将支配某种自然现象的要素以及这些要素之间的关系归纳为数学表达式,如控制方程5,然后对分析对象进行建模,以便进行计算机模拟。接下来,将控制方程应用到模型中,进行数学计算,最后将计算结果应用于现象进行分析。计算机模拟分析方法主要分为:有限差分法(Finite Difference Method)、有限元法(Finite Element Method, FEM)和有限体积法(Finite Volume Method)。其中,有限元法被广泛应用于分析半导体结构。从工程角度而言,有限元法指将无限数量的点和自由度6转化为有限数量的点和自由度的能力,这些点随后被纳入线性方程组进行计算。

5 控制方程(Governing Equation):构成计算机代码基础的数学公式。在计算建模场景中,控制方程决定由代码提前预设的隐藏的流体行为。
6 自由度(Degrees of Freedom):对某一统计量进行最终计算时,可以自由变化的数值的个数。
有限元法由有限数量的被称为元素的构建模块组成。每个元素都包含有限数量的点和一个控制方程,而数值则通过求解方程获得。为了深化对结构分析的了解,我们有必要知道结构分析所需材料的三个关键属性:热膨胀系数(CTE)、泊松比(Poisson’s Ratio)和应力(Stress)。
热膨胀系数是用来描述材料因温度波动而发生长度变化的一项指标。一般来说,温度升高时材料膨胀,温度下降时材料收缩。因此,热膨胀系数被定义为单位温度上升时材料长度的增幅量。泊松比指材料在垂直于特定载荷方向上的膨胀或收缩,考虑物体所受的推拉作用可有助于我们更好地了解泊松比的概念。如果我们从两端纵向拉动一个物体并对其施加拉力,那么物体会沿着长度方向伸展,沿着宽度方向收缩。但是,如果我们从两端纵向推挤一个物体并对其施加压缩力,那么物体会沿着这个力的方向收缩,沿着宽度方向伸展。最后,应力指物体在受到外部作用时在内部形成的内力,用以抵抗这股外力,同时保持物体的形状不变。应力压力是以单位进行测量的。
这些材料特性应用于半导体封装结构分析的三个主要领域:封装翘曲、焊点可靠性和封装强度。
在进行封装时,当温度上升然后回落到室温时,不同材料之间由于热膨胀系数不同,可能导致封装翘曲并造成封装缺陷。因此,我们应基于产品结构、材料的弹性模量7、热膨胀系数、工艺温度和时间,对封装进行结构性分析,以便更好地预防翘曲及封装缺陷。
7 弹性模量(Elastic Modulus):在固体力学中表示材料刚度的数值,是应力与应变的比值。
焊锡主要用于半导体封装和PCB基板之间的机械和电气连接。由于焊点可靠性非常重要,所以我们需要在封装前对焊点进行结构性分析,以改进封装结构和材料。
焊锡的失效主要源于两个方面的共同作用——平面收缩造成的剪切断裂以及轴向拉伸造成的拉伸断裂。因此,在焊点结构分析中,需要对各种工艺或使用条件下施加到焊点的应力值进行分析。
因为封装的作用是保护芯片免受外部影响,所以芯片在受外部影响时表现出的稳健性要依靠封装强度。为了确定封装的稳健性,我们可以使用万能试验机(UTM)8进行三点弯曲或四点弯曲试验,由此计算断裂强度。结构性分析可以模拟用万能试验机进行的实验,从而推导出封装各个区域的应力水平,并以特定材料的断裂强度为参考来预测整个产品的断裂强度。
8 万能试验机(UTM):一种测量材料强度的仪器,通过用一定重量拉伸或压缩材料来测量其抗拉、抗弯和抗压强度。
四有芯人注:UTM,即Universal Testing Machine。
电子设备在运行时会消耗电能并产生热量。这种热量会提高包括半导体产品在内元件的温度,从而损害电子设备的功能性、可靠性和安全性。因此,电子设备必须配备适当的冷却系统,以确保元件在任何环境下均能保持在一定温度水平下。
鉴于散热性能在半导体封装中的重要作用,热分析也成为了一项必不可少的测试内容。因此,必须提前准确了解半导体封装在系统应用时产生的热量、封装材料与结构的散热效果、以及温度效应,并将其反应在封装设计中。
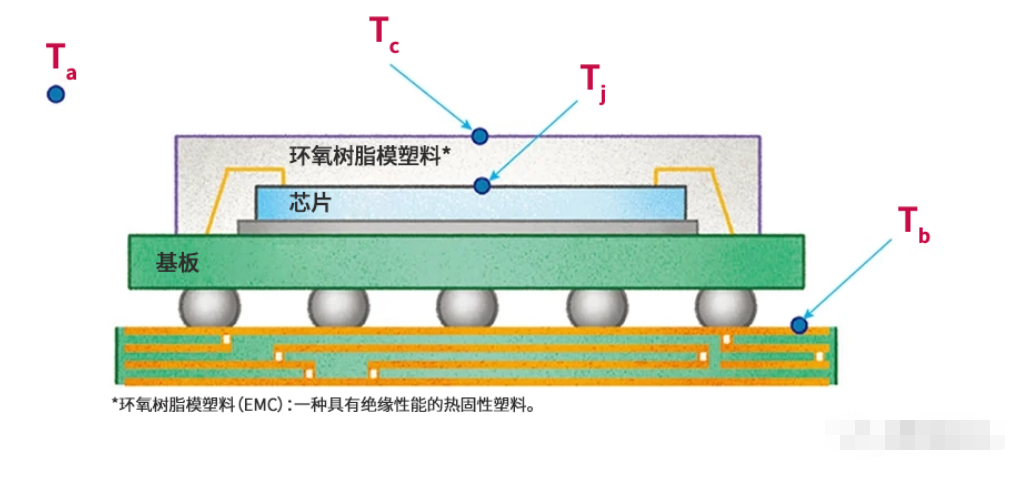
▲图3:封装的关键温度点(ⓒ HANOL出版社)
对半导体封装实施并使用热分析,我们需要定义封装的关键温度点,包括:环境温度(Ta)、结温(Tj)、壳温(Tc)和板温(Tb)。封装规格的温度通常为最高结温(Tj max.)或者最高壳温,这两点指的是确保半导体器件正常工作的最高温度。图3显示了封装原理示意图中的各个温度点。
四有芯人注:Ta: ambient temperature; Tj: junction temperature; Tc: case temperature; Tb: board temperature.

▲图4:封装中的热特性类型(ⓒ HANOL出版社)
使用封装的主要温度点可以计算出热阻,热阻是最重要的热保护特性。封装热阻是一个指数,单位为℃/W,表示当芯片产生1瓦热量时,半导体产品相对于环境温度所上升的温度。该比值根据每种产品和环境条件而变化。常见的热阻类型包括结到环境热阻(Ja)、结到板热阻(Jb)和结到壳热阻(Jc),它们是封装的抗热性指标。
电气模拟

▲图5:封装RLGC模型示例(ⓒ HANOL出版社)
随着半导体芯片传输速度的提升和密度的增大,封装也对半导体产品的特性产生重大影响。特别是在封装高性能半导体芯片时,必须要对封装状态进行精确的电气模拟。为了预测由高性能半导体芯片的复杂布线引起的电气问题,需要使用诸如RLGC等模型。因此,电气模拟可以创建各种模型,并利用这些模型来预测高速数字系统中的数据传输用时、信号质量和形状精度。
在封装电气分析过程中,电气模型的基本元素包括电阻(Resistance)、电感(Inductance)和电容(Capacitance)。电阻的强度足以阻碍电流的流动,它与物体中的单位电流成反比。电感是电路中电流变化引起的电磁感应形成的反电动势的比率。最后,电容是电容器在单位电压作用下储存电荷的物理量。
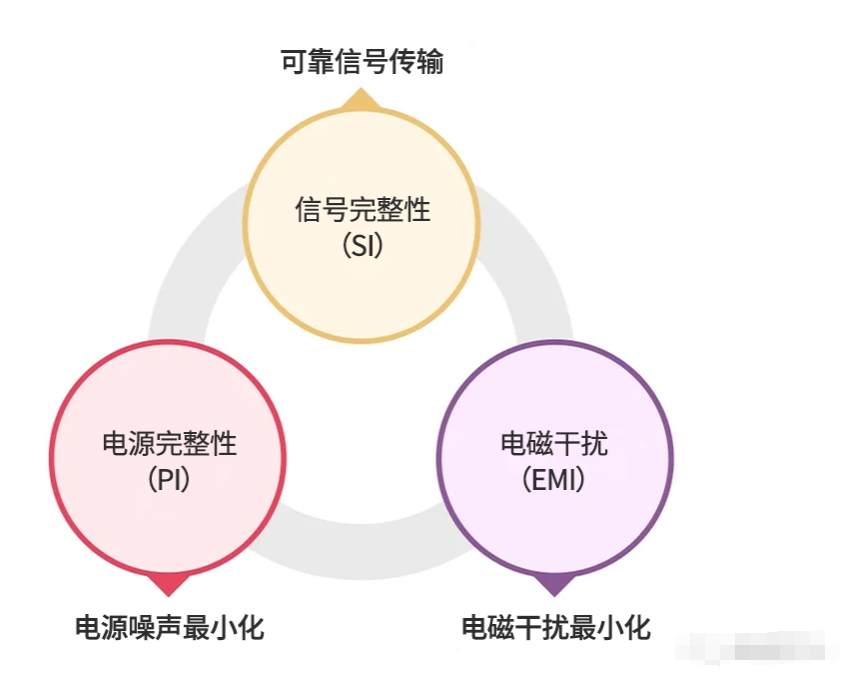
▲图6:电气分析的不同方面(ⓒ HANOL出版社)
如图5所示,利用RLGC建模,可以预测的最重要特性,即信号完整性(SI)、电源完整性(PI)和电磁干扰(EMI)。信号完整性衡量的是电信号的质量,电源完整性衡量的是电源传输的质量。最后,EMI指电磁干扰,即辐射或传导的电磁波会干扰其他设备的运行的因素。因此,应提前检查噪声问题,尽可能缩短其发展周期,确保电源完整性和电源配送系统能够支持创建可靠的电路板。信号完整性、电源完整性和电磁干扰之间存在着密切的有机联系,因此,综合考量这三种特性的设计方案对于电气分析至关重要。
半导体封装清洗
半导体芯片封装过程中通常会使用助焊剂和锡膏等作为焊接辅料,这些辅料在焊接过程或多或少都会有部分残留物,还包括制程中沾污的指印、汗液、角质和尘埃等污染物。同时,半导体组装了铝、铜、铂、镍等敏感金属和油墨字符、电磁碳膜和特殊标签等相当脆弱的功能材料。这些敏感金属和特殊功能材料对清洗剂的兼容性提出了很高的要求。
合明半水基清洗工艺解决方案,可在清洗芯片封装基板的焊接残留物和污垢的同时去除金属界面高温氧化膜,保障下一道工序的金属界面结合强度;对芯片半导体基材、金属材料拥有优良的材料兼容性,清洗后易于用水漂洗干净。
欢迎使用 半水基清洗剂W3300!
运用自身原创的产品技术,满足芯片封装工艺制程清洗的高难度技术要求,打破国外厂商在行业中的垄断地位,为芯片封装材料全面国产自主提供强有力的支持。
以上便是芯片封装基板清洗,封装基板的主要结构和生产技术的介绍,希望可以帮到您!
上一篇:助焊剂的性能特点





![[x]](/template/default/picture/closeimgfz1.svg)