因为专业
所以领先
SIP清洗之SiP工艺分析(下)
SIP封装制程按照芯片与基板的连接方式可分为引线键合封装和倒装焊工艺两种。下面小编给大家重点科普一下倒装焊工艺,希望能对您有所帮助!
SIP倒装焊工艺和SIP引线键合工艺相比较倒装焊工艺具有以下几个优点:
1、倒装焊技术克服了引线键合焊盘中心距极限的问题;
2、在芯片的电源 /地线分布设计上给电子设计师提供了更多的便利;
3、通过缩短互联长度,减小 RC 延迟,为高频率、大功率器件提供更完善的信号;
4、热性能优良,芯片背面可安装散热器;
5、可靠性高,由于芯片下填料的作用,使封装抗疲劳寿命增强;
6、便于返修。
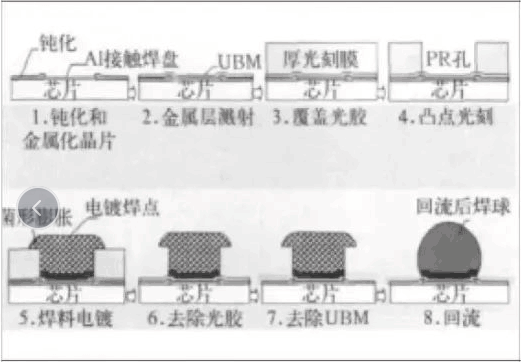
SIP倒装焊的工艺流程如下(与引线键合相同的工序部分不再进行单独说明):
圆片→焊盘再分布→圆片减薄、制作凸点→圆片切割→倒装键合、下填充→包封→装配焊料球→回流焊→表面打标→分离→最终检查→测试→包装。
焊盘再分布:
为了增加引线间距并满足倒装焊工艺的要求,需要对芯片的引线进行再分布。
制作凸点:
焊盘再分布完成之后,需要在芯片上的焊盘添加凸点,焊料凸点制作技术可采用电镀法、化学镀法、蒸发法、置球法和焊膏印刷法。目前仍以电镀法最为广泛,其次是焊膏印刷法。
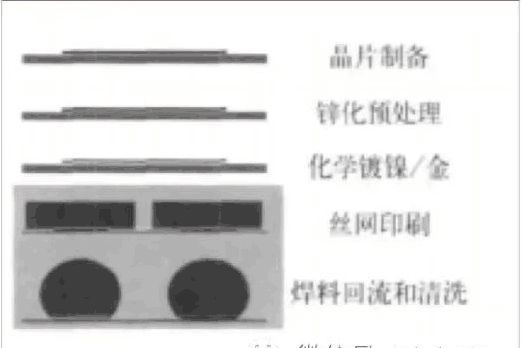
倒装键合、下填充:
在整个芯片键合表面按栅阵形状布置好焊料凸点后,芯片以倒扣方式安装在封装基板上,通过凸点与基板上的焊盘实现电气连接,取代了WB和TAB 在周边布置端子的连接方式。倒装键合完毕后,在芯片与基板间用环氧树脂进行填充,可以减少施加在凸点上的热应力和机械应力,比不进行填充的可靠性提高了1到2个数量级。
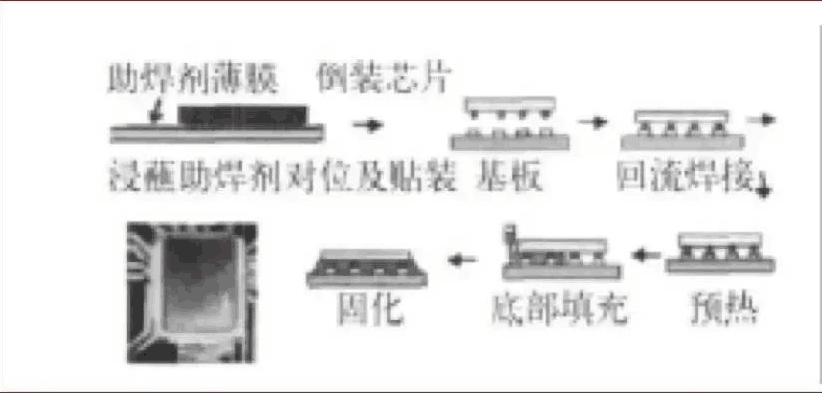
以上是关于SIP清洗之SiP工艺分析(下)的相关内容介绍了,希望能对您有所帮助!
想要了解关于SIP系统级封装清洗清洗的相关内容,请访问我们的“SIP系统级封装清洗”专题了解相关产品与应用 !
是一家电子水基清洗剂 环保清洗剂生产厂家,其产品覆盖助焊剂、PCBA清洗、线路板清洗、电路板清洗、半导体清洗 、芯片清洗、SIP系统级封装清洗、POP堆叠芯片清洗、倒装芯片清洗、晶圆级封装清洗、助焊剂清洗剂等电子加工过程整个领域!





![[x]](/template/default/picture/closeimgfz1.svg)