因为专业
所以领先
POP封装在未来的发展趋势与PoP堆叠芯片清洗介绍
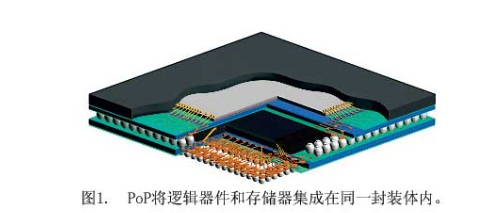
POP(Package on Package)堆叠封装是一种将多个集成电路(IC)封装在一起的技术,以实现更小、更轻、更薄的电子设备。在POP封装中,一个封装(通常是一个存储器芯片)被堆叠在另一个封装(通常是应用处理器)之上,通过焊球连接。这种技术可以提高电路板空间利用率,降低设备的整体尺寸和重量,并提高性能。
一、POP封装的优点包括:

1. 小型化:通过堆叠多个封装,可以在有限的空间内实现更多的功能。
2. 高度集成:可以将多种功能的芯片集成在一个封装内,简化电路设计。
3. 提高性能:堆叠封装可以缩短信号传输距离,从而提高数据传输速度和系统性能。
4. 节省成本:通过减少电路板空间需求,可以降低材料成本和生产成本。
然而,POP封装也存在一些挑战,如散热问题、可靠性问题和制造难度等。因此,在选择使用POP封装时,需要综合考虑这些因素。
二、以下是一些采用了POP封装技术的电子产品:
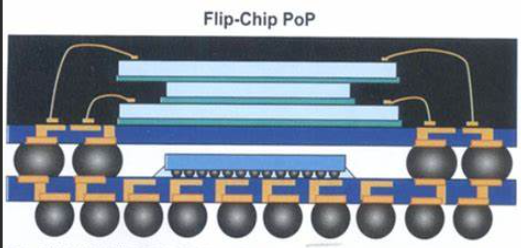
1. 智能手机:PoP封装技术在智能手机领域得到了广泛的应用。例如,魅族手机16S就采用了PoP封装技术来集成应用处理器与存储器。此外,随着新兴应用对集成度、电性能以及超薄化等要求的进一步提高,各家厂商的PoP封装技术也在不断创新发展。
2. 新一代可穿戴设备:PoP封装技术也被广泛应用于新一代可穿戴设备等领域。
3. 电子手表:随着电子产品的不断发展,电子手表也越来越追求体积小便携,电性能优秀,价格低。封装技术的发展是电子产品性能提升和价格下降的关键因素之一。层叠封装pop就是一种解决移动设备芯片封装难题的有效方案。
4. 耳机:例如,魅族POPPro主动降噪耳机就是采用了PoP封装技术的产品。
5. 健康手表:华米科技发布的全新健康手表”AmazfitPop,售价仅349元,成为市面上最便宜的血氧检测手表之一。
以上产品都是采用了PoP封装技术的电子产品。

三、保证PoP封装的可靠性主要包括以下几个方面:
1. SMT工艺的可靠性:PoP的SMT工艺的可靠性是一个重要的关注点。由于锡膏印刷已经不可能在底部元件上完成,顶层CSP元器件这时需要特殊工艺来装配了,需要将顶层元件浸蘸助焊剂或锡膏后以低压力放置在底部CSP上。此外,元器件翘曲变形对装配良率的影响也非常关键,翘曲变形可能导致焊点开路。翘曲变形既有来自元件在封装过程中的变形,也有因为回流焊接过程中的高温引起的热变形。
2. 封装结构的可靠性:PoP封装的结构相对比较复杂,其散热问题、封装材料间热膨胀系数不匹配造成的热失配问题及在跌落冲击载荷下的可靠性问题制约着PoP封装的进一步发展。在热循环和湿热环境下的可靠性研究比较少。在热循环载荷下,顶部和底部模块对称中心最远端焊点的应力最大,单个焊点呈两端大中间小的分布趋势。最大累积等效蠕变应变位于内层焊点,且在芯片边缘。
3. 封装材料的可靠性:封装材料的选择也会影响PoP封装的可靠性。例如,AlN、SiC、BeO、Al2O3四种基板材料中,热膨胀系数最大的BeO基板具有最大的热疲劳寿命。
4. 封装测试的可靠性:封装堆叠PoP作为一种新型的封装形式,其具有很强的灵活性和扩展性,缩短了产品的上市时间,允许装配前各模块单独测试,保证了更高的良品率。在回流焊载荷下,顶部和底部模块的最大应力出现在底层芯片的四个边角,其大小值分别为59.35Mpa和15.6Mpa。在峰值温度时,顶部和底部模块的形变分别为10μm和-58μm,两者的翘曲模式不同,翘曲差值为68μm。
5. 封装维修的可靠性:PoP封装的主要作用是在底层封装中集成高密度的数字或者混合信号逻辑器件,在顶层封装中集成高密度或者组合存储器件。但是,维修也比较困难,大多数情况下拆卸下来的芯片基本不能再次利用。
总的来说,保证PoP封装的可靠性需要从多个方面进行综合考虑和控制。
四、POP封装在未来的发展趋势
1. 超薄化趋势下的封装翘曲问题
随着封装技术的进一步超薄化,封装翘曲成为一大问题。封装中使用了各种不同的材料,如芯片、基板、塑封等,这些材料具有不同的热膨胀系数(CTE)。当封装变薄后,钢性显著降低,更容易变形,使得翘曲显著加大。过大的翘曲会使得PoP封装在表面焊接(SMT)组装过程中,底层封装与母板之间,或者底层和上层封装之间的焊锡球无法连接,出现开路。超薄化的趋势使得翘曲问题更加突出,成为一个阻碍未来PoP薄化发展的瓶颈。
2. 发展趋势
新一代层叠封装(PoP)的发展趋势可以概括为:IC集成度进一步提高,芯片尺寸不断加大,芯片尺寸与封装尺寸比例不断提高,使得封装翘曲也随之增加。对封装的电性能要求进一步提高,倒装芯片技术(flipchip)应用普及,已代替了传统的焊线(wirebond)技术。同一芯片针对不同应用及客户要求采用不同封装尺寸。这些都使得封装难以采用传统的统一的材料系统,而必须定制优化。此外,PoP底层和上层之间互连的间距(pitch)缩小,传统PoP采用0.5mm或以上间距,现在多采用0.4mm间距。不远的将来,0.3mm间距将出现。间距的缩小使得上下层互连的焊锡高度产生问题。在超薄化趋势下,PoP封装的各层材料厚度要求越来越薄。
3. 技术创新与材料优化
为了进一步利用PoP技术的优势,系统公司可以同芯片供应商与封装公司合作,对PoP底层或上层元件进一步集成,以满足其产品需要。例如,基带芯片和应用处理器芯片可以集成在PoP的底层封装里。随着集成度及电性能要求的进一步提高,以及超薄化的需求,PoP封装技术也不断发展创新,开始进入新的一代。许多新的PoP技术的开发及新材料的应用也是针对降低封装翘曲。
4. 未来的挑战与机遇
尽管面临着封装翘曲等挑战,但PoP封装技术的超薄化趋势为行业带来了更多的机遇。随着技术的进步和材料的优化,翘曲控制将成为未来PoP封装技术发展的一个重要方向。同时,随着便携式移动设备的需求不断增加,PoP封装技术在小型化和薄型化方面的优势将得到更大的发挥。
总的来说,未来POP封装的发展趋势将是超薄化、技术创新和材料优化,但同时也需要面对封装翘曲等挑战。
五、c:
PoP堆叠芯片/Sip系统级封装在mm级别间距进行焊接,助焊剂作用后留下的活性剂等吸湿性物质,较小的层间距如存有少量的吸湿性活性剂足以占据相对较大的芯片空间,影响芯片可靠性。要将有限的空间里将残留物带离清除,清洗剂需要具备较低的表面张力渗入层间芯片,达到将残留带离的目的。 研发的清洗剂具有卓越的渗入能力,以确保芯片间残留活性剂被彻底清除。
针对先进封装产品芯片焊后封装前,基板载板焊盘、电子制程精密焊后清洗的不同要求, 在水基清洗方面有比较丰富的经验,对于有着低表面张力、低离子残留、配合不同清洗工艺使用的情况,自主开发了较为完整的水基系列产品,精细化对应涵盖从半导体封装到PCBA组件终端,包括有水基清洗剂和半水基清洗剂,碱性水基清洗剂和中性水基清洗剂等。具体表现在,在同等的清洗力的情况下, 的兼容性较佳,兼容的材料更为广泛;在同等的兼容性下, 的清洗剂清洗的锡膏种类更多(测试过的锡膏品种有ALPHA、SMIC、INDIUM、SUPER-FLEX、URA、TONGFANG、JISSYU、HANDA、OFT、WTO等品牌;测试过的焊料合金包括SAC305、SAC307、6337、925等不同成分),清洗速度更快,离子残留低、干净度更好。
想了解更多关于先进封装产品芯片清洗的内容,请访问我们的“先进封装产品芯片清洗”产品与应用!
运用自身原创的产品技术,满足芯片封装工艺制程清洗的高难度技术要求,打破国外厂商在行业中的垄断地位,为芯片封装材料全面国产自主提供强有力的支持。
推荐使用 水基清洗剂产品。



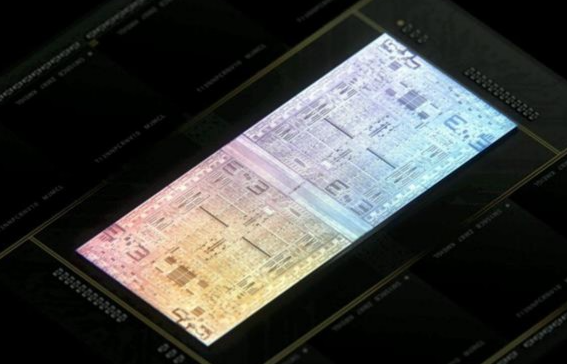

![[x]](/template/default/picture/closeimgfz1.svg)