因为专业
所以领先
倒装芯片基板技术与倒装芯片清洗剂介绍
倒装芯片(Flip Chip)技术,又称FC(Flip Chip)封装,是一种先进的芯片互连技术,其核心在于直接将芯片的裸die(未封装的集成电路)通过焊球(通常是金、铜或锡铅合金制成)面对面地连接到封装基板上,从而替代传统的引线键合技术。这一过程涉及芯片的“翻转”,即芯片的活性面朝下,直接与基板相连,故得名“倒装”。
倒装芯片基板技术,作为半导体封装领域的一项革命性进展,正逐步重塑着集成电路(IC)的生产与应用格局。倒装芯片基板技术不仅显著提升了芯片的性能表现,还优化了电路板的空间利用率,为电子产品的小型化、高性能化开辟了新的道路。
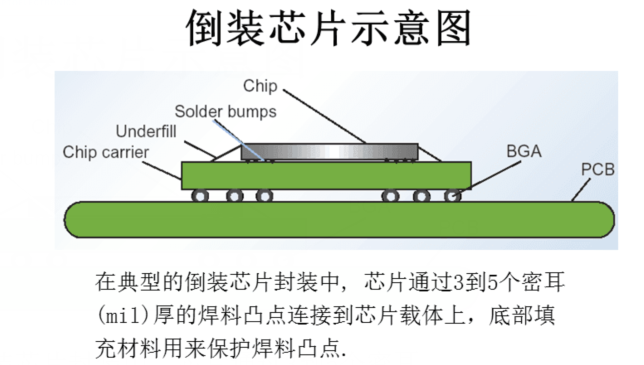
基本原理与工艺流程:
倒装芯片基板技术的核心在于利用微小的凸点(Bumps),通常直径在几十到几百微米之间,直接焊接在芯片的I/O(输入/输出)端口上。随后芯片被翻转放置在封装基板上,凸点与基板上的对应焊盘精确对齐并加热熔接,形成电气连接。这一过程通常伴随着底部填充(Underfill)技术的应用,即在芯片和基板之间的空隙注入树脂材料,以增强结构稳定性,提高热循环和机械应力承受能力。

倒装芯片清洗剂W3805介绍:
倒装芯片清洗剂W3805针对焊后残留开发的具有创新型的无磷无氮 PH中性配方的浓缩型水基清洗剂。适用于SiP系统封装清洗及清洗不同类型的电子组装件上的焊剂、锡膏残留。由于其PH中性,对敏感金属和聚合物材料有极佳的材料兼容性。
倒装芯片清洗剂W3805的产品特点:
1、本品无磷、无氮、清洗能力好。
2、不燃不爆,使用安全,对环境友好。
3、材料安全环保,创造安全环保的作业环境,保障员工身心健康。
4、可极大提高工作效率,降低生产成本。
倒装芯片清洗剂W3805的适用工艺:
无磷无氮水基清洗剂W3805适用于喷淋清洗工艺。
倒装芯片清洗剂W3805产品应用:
W3805是创新型浓缩型水基清洗剂,清洗时可根据残留物的清洗难易程度,用去离子水稀释后再进行使用。
适用于SiP系统封装清洗及清洗不同类型的电子组装件上的焊剂、锡膏残留。由于其 PH 中性,对敏感金属和聚合物材料有极佳的材料兼容性。






![[x]](/template/default/picture/closeimgfz1.svg)