因为专业
所以领先
1、 2.5D/3D封装:多层芯片堆叠,AI驱动下HBM需求大增,CoWoS产能成为算力关键卡口
2.5D封装和3D封装的区别在于是否有硅中阶层(Si Interposer)。在2.5D封装中,所有芯片和被动元器件均在基板平面上方,至少有部分芯片和被动元器件安装在中介层上,中介层通常作为一个载体,承载着各种电路组件和接口。而3D封装舍弃中介层,直接在芯片上打孔和布线,电气连接上下层芯片。所有芯片和被动元器件器件均位于基板平面上方,芯片堆叠在一起,在基板平面的上方有穿过芯片的硅通孔(TSV),在基板平面的下方有基板的布线和过孔。
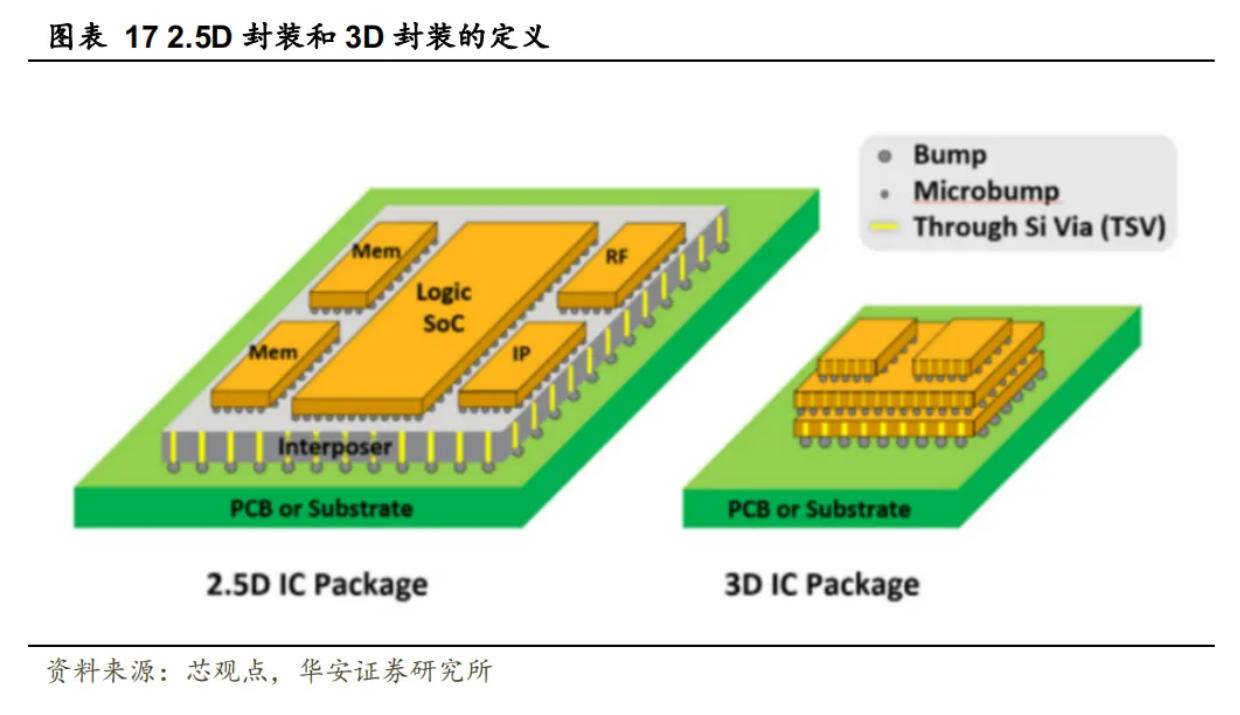
2.5D/3D封装的关键工艺是硅通孔技术(through silicon via, TSV)。TSV是一种垂直互连技术,其概念由威廉·肖克利于1958年首次提出,是指连接硅晶圆两面并与硅衬底以及其他通孔绝缘的电互连结构。TSV的尺寸通常在10μm×100μm和30μm×200μm之间,开口率介于0.1%~1%。与传统平面互连相比,TSV能够缩短互连长度、减小信号延迟、降低寄生电容和电感,实现芯片间低功耗和高速通信,同时增加宽带并实现封装的小型化。TSV目前主要应用于芯片三维堆叠、硅转接板等领域。硅转接板是芯片和有机基板的中间层,分为无源和有源两类,其中无源转接板仅包含金属互连层,而有源转接板则可集成供电、片内网络通信等功能。

根据TSV被制作的时间顺序,有3种类型的TSV工艺。分为先通孔工艺(Via First)、中通孔工艺(Via Middle)和后通孔工艺(Via Last),分别指TSV制作在晶圆制作工艺中的前、中或后段。
Via First是指在器件(如MOSFET器件)结构制造之前,先进行TSV结构的通孔刻蚀,孔内沉积高温电介质(热氧沉积或化学气相沉积),然后填充掺杂的多晶硅。多余的多晶硅通过CMP去除。
Via Middle常常指在形成器件之后但在制造叠层之前制造的通孔工艺。在有源器件制程之后形成TSV结构,然后内部沉积电介质。淀积阻挡层钛金属和铜种子层,然后电镀铜填充通孔,或通过化学气相沉积钨金属填充通孔。
Via Last包括两种工艺。正面后通孔工艺是在Back End of Line(BEOL)工艺处理结束后,从晶圆正面形成通孔的一种制造工艺。从概念上讲,在晶圆上制造的后通孔工艺与中通孔工艺相似,但是对工艺温度有进一步的限制(必须小于400℃)。背面后通孔工艺是在BEOL工艺处理结束后,从晶圆背面进行通孔结构的一种制造工艺。首先使用粘合剂将两个器件晶圆以面对面方式粘合,接下来,将顶部晶圆减薄,将TSV结构刻蚀至顶部晶圆和底部晶圆上的焊盘,孔内沉积电介质,最后,将金属沉积到TSV结构中并进行表面金属层再布线。

HBM使用2.5D/3D封装技术打破“内存墙”制约,成为AI及高性能计算需求下的主流方案。高带宽内存(High Bandwidth Memory, HBM)通过逻辑芯片和多层的DRAM堆叠来实现高速数据传输,突破了带宽瓶颈,成为AI训练芯片的首选。第一代HBM的架构如下图所示,由4层DRAM和逻辑芯片堆叠在一起,每层之间通过TSV和微凸点连接。每个HBM有8个通道,每个通道有128个I/O,因此每个HBM有1024个I/O,即合计1024个TSV位于HBM的中间区域。存储器和处理器通过无源转接板上的再布线层(RDL)将HBM逻辑芯片的端口物理层(Port Physical Layer, PHY)与处理器的PHY相连。HBM的性能较传统GDDR5更具优势,GDDR5的带宽最高可达32 GB/s,而HBM1、HBM2和HBM2的带宽分别达到了128 GB/s、307 GB/s和819 GB/s。其中,HBM内部的DRAM堆叠属于3D封装,而HBM与芯片其他部分合封于硅中介层上属于2.5D封装。

HBM的带宽提升源于堆栈式封装带来的高位宽以及I/O速率的提升。1)位宽:HBM的位宽是GDDR5的32倍。显存带宽是指显示芯片与显存之间的数据传输速率,带宽的计算公式为:显存带宽(GB/s) = 显存实际频率(MHz) × 显存数据倍率 × 显存等效位宽(bit) / 8。GDDR5的频率可达1750 MHz,采用4倍速率机制,其等效频率为7000 MHz,但GDDR5内部I/O位宽仅32 bit;相比之下,HBM的频率为500 MHz,采用2倍速率机制,等效频率为1000 MHz,但HBM内部I/O位宽高达1024 bit,将带宽提升至128 GB/s。HBM之所以能实现32倍于GDDR5的I/O位宽,是因为它采用了堆栈式设计,通过TSV堆栈方式将DRAM裸片垂直堆叠放置,从而实现在相同底面积上布置了数倍的DRAM颗粒,以达到更高的I/O数量。2)I/O速率:在数值上,显存速率和显存频率是相等的,使带宽计算公式简化为:显存带宽(GB/s) = 显存数据速率(Gbps) × 显存等效位宽(bit) / 8。这是因为显存速率表示每秒传输的数据位数,单位为bps (bits per second)。显存频率以MHz为单位,频率单位赫兹的本质就是,描述了单位时间内完成周期性变化的次数。因此,在数值上,显存速率和显存频率是相等的。根据JEDEC固态技术协会发布的HBM3标准,HBM3定义高达6.4 Gb/s的数据速率,堆栈中的DRAM芯片数量(四到十六个)及其具体容量(每堆栈4 GB到64 GB)不等,计算得到初始HBM3堆栈可提供每堆栈819GB/s的传输带宽。

HBM堆栈层数增加对芯片间键合技术提出更高的要求,关键改进是使用混合键合替代原来的微凸点键合。混合键合是一种实现介质层与介质层、金属与金属界面无缝隙键合的技术,芯片键合界面由介质层(通常为SiO2)和金属(通常为Cu)组成。SiO2介质层为集成单元提供机械支撑与电气隔离,Cu-Cu键合提供芯片间的垂直电气互连。对于Cu和SiO2混合键合结构,首先要对键合表面进行等离子或快速原子束表面激活处理,之后进行直接键合,最后进行退火处理。退火在增强SiO2-SiO2键合强度的同时,也促进了Cu晶粒的生长和扩散以实现Cu-Cu键合。海力士计划将混合键合技术应用于下一代HBM4产品,混合键合技术可以大幅缩小电极尺寸,从而实现更高的I/O密度,同时可以显著缩小芯片之间的间隙,减少产品厚度。
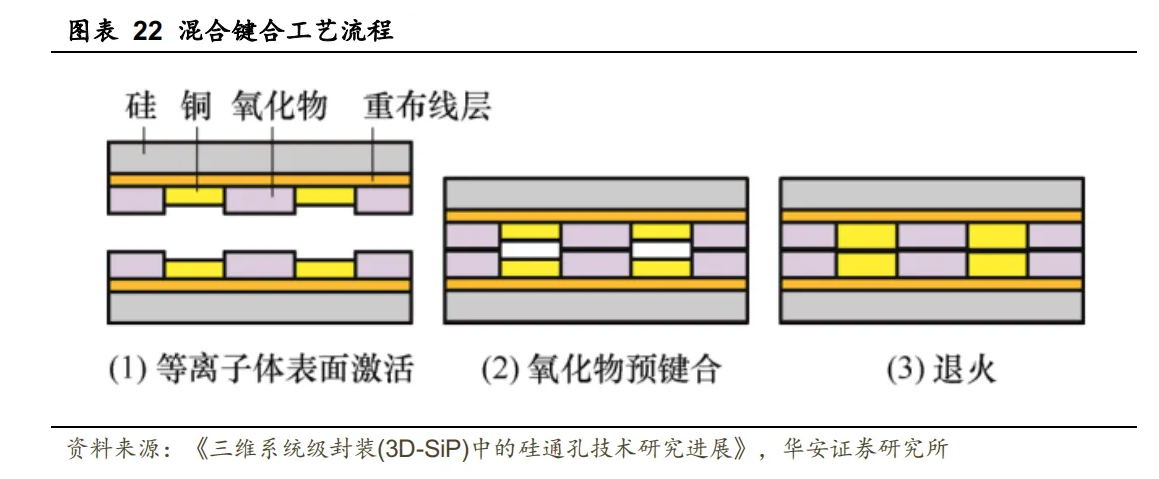
混合键合的主要优点包括:1)缩小互联间距:它可以实现超细间距的芯片互连,比传统微凸点连接提高了10倍以上。超细间距的连线将增加布线的有效使用面积,增加通道数量,并实现数据处理串并行转换,简化I/O端口电路,增大数据传输带宽。2)降低信号延时:它可以实现芯片之间的无凸点互连通信,取消微凸点连接,进一步降低通道的寄生电感性和信号延时。3)减薄芯片厚度:混合键合可以实现超薄芯片的制备,通过芯片的减薄可以大幅降低芯片的厚度和重量,并进一步提升互连带宽;4)提高键合可靠性:混合键合还可以提高键合的可靠性,通过分子尺度的铜-铜触点融合和二氧化硅-二氧化硅的分子共价键连接,大幅提高了界面键合力,增强了芯片对环境的适应性。

HBM的高密度连接和短互联间距,要求台积电的CoWoS封装技术。CoWoS是台积电于2012年研发的一种2.5D集成封装技术,可分为CoW和oS两步,CoW(chip on wafer)是将计算核心、I/O die、HBM等芯片封装在硅中介层上;然后再把CoW芯片整体封装在基板(Substrate)上,即oS(on substrate)环节。CoWoS可以节省空间,实现HBM所需的高互联密度和短距离连接;还能将不同制程的芯片封装在一起,在满足AI、GPU等加速运算的需求的同时控制成本。目前所有先进的AI计算芯片都使用HBM,而几乎所有HBM都封装在CoWoS上。

根据中介层材料的不同,CoWoS有三种变体:CoWoS-S(中介层是Si衬底)、CoWoS-R(中介层由RDL构成)和CoWoS-L(中介层由Chiplet和RDL组成),其中CoWoS-S为量产主要配置。CoWoS-S利用硅片作为桥梁,芯片互联密度最高;出于成本的考虑,CoWoS-R采用有机转接板,但也导致芯片互联密度较低;CoWoS-L将小硅桥安装在有机转接板中,仅在芯片链接部分使用硅片,实现邻近芯片边缘的高密度连接,生产成本和性能介于CoWoS-R和CoWoS-S之间。

2024年,CoWoS预计为台积电带来70亿美元营收。AI需求驱动下,CoWoS在台积电营收的比重逐渐上升。根据Information Network估计,2022/2023/2024年CoWoS收入占台积电营收的比例将分别达到7.00%/7.49%/8.21%。以台积电2024年全年营收指引852.37亿美元估算,AI将带来约69.94亿美元的CoWoS营收,较2023年同比增长34.69%。

CoWoS的绝大多数需求来自AI。英伟达的H100、A100均由台积电代工,并使用CoWoS先进封装。根据Omdia,2023Q3英伟达售出近50万个A100和H100 GPU,Meta和微软是最大买家,其次是谷歌、亚马逊、甲骨文和腾讯。得益于人工智能和高性能计算的需求,本财年第三季度,Nvidia在数据中心硬件上获得了145亿美元的收入。庞大的需求量导致CoWoS产能供不应求。除了英伟达外,AMD的最新AI GPU产品MI300也导入台积电的CoWoS(2.5D)和SoIC(3D)的技术。此外,还有一系列ASIC芯片,如英特尔的Habana Gaudi、谷歌的TPU v5e、亚马逊的Inferentia和Trainium芯片等。

根据我们的测算,CoWoS封装的单价为722.08美元/颗,2023年/2024年基于CoWoS的芯片出货量将达到346万颗/693万颗,其中供给英伟达的芯片分别为130万颗/433万颗。按照12英寸晶圆面积70695 mm²和H100、A100、Epic Genoa、MI300四种AI芯片平均面积980mm²,测算得到每张晶圆上芯片数约72颗。根据Information Network给出的2022年CoWoS月产能为8500片以及前文测算的2022年台积电CoWoS收入,得到单颗芯片CoWoS封装价格约为722.08美元。而根据DigiTimes的报道,2023年CoWoS年产能约12万片,2024年将冲上24万片,其中英伟达将取得14.4-15万片。由于这些芯片多在7nm和5nm节点生产,保守假设良率为40%。我们以英伟达2023年和2024年分别取得4.5万片和15万片的产能来算,预计英伟达出货量约130万颗和433万颗。全体AI芯片出货量约346万颗和693万颗,对应2023年/2024年CoWoS将产生25亿美元/50亿美元收入。

供需短缺情况将在13个月内得到缓解,非台积供应链(non TSMC)有机会受益。台积电已于2023年第二季度开始采取行动扩产,包括将部分InFO产能从龙潭转移至南科,以便在龙潭转扩CoWoS产能。2023年7月25日,台积电宣布拟投资900亿新台币(约206亿元人民币)于竹科辖下铜锣科学园区新建先进封装厂,以加速扩产CoWoS产能,预计2026年底建厂完成,2027年开始量产。此外,台积电同时也将部分委外至其他封测厂,联电、安靠、矽品等均提供产能支持。影响CoWoS扩产的关键是设备交货时间较长。台积电董事长刘德音在2023年9月6日出席大师论坛专题演讲会时称,CoWoS预期1年半后可100%满足客户需求。因此对非台积供应链来说,在CoW端接单的窗口期已不足13个月,加之扩产时间考虑,各封测厂商对于扩产态度与规模较为保守。
芯片封装清洗剂选择:
水基清洗的工艺和设备配置选择对清洗精密器件尤其重要,一旦选定,就会作为一个长期的使用和运行方式。水基清洗剂必须满足清洗、漂洗、干燥的全工艺流程。
污染物有多种,可归纳为离子型和非离子型两大类。离子型污染物接触到环境中的湿气,通电后发生电化学迁移,形成树枝状结构体,造成低电阻通路,破坏了电路板功能。非离子型污染物可穿透PC B 的绝缘层,在PCB板表层下生长枝晶。除了离子型和非离子型污染物,还有粒状污染物,例如焊料球、焊料槽内的浮点、灰尘、尘埃等,这些污染物会导致焊点质量降低、焊接时焊点拉尖、产生气孔、短路等等多种不良现象。
这么多污染物,到底哪些才是最备受关注的呢?助焊剂或锡膏普遍应用于回流焊和波峰焊工艺中,它们主要由溶剂、润湿剂、树脂、缓蚀剂和活化剂等多种成分,焊后必然存在热改性生成物,这些物质在所有污染物中的占据主导,从产品失效情况来而言,焊后残余物是影响产品质量最主要的影响因素,离子型残留物易引起电迁移使绝缘电阻下降,松香树脂残留物易吸附灰尘或杂质引发接触电阻增大,严重者导致开路失效,因此焊后必须进行严格的清洗,才能保障电路板的质量。
研发的水基清洗剂配合合适的清洗工艺能为芯片封装前提供洁净的界面条件。
运用自身原创的产品技术,满足芯片封装工艺制程清洗的高难度技术要求,打破国外厂商在行业中的垄断地位,为芯片封装材料全面国产自主提供强有力的支持。
推荐使用 水基清洗剂产品。





![[x]](/template/default/picture/closeimgfz1.svg)