先进封装行业概览与先进封装技术代表介绍
一、先进封装行业概览
半导体制造产业主要分为设计,制造和封测三大环节。
上游支撑产业为EDA、半导体材料和半导体设备,下游应用产业为消费电子、通讯产业等。
其中封测行业属于半导体晶圆前道制造之后的工序,主要分为封装和测试两大细分环节。
封装是指将生产加工后的晶圆进行切割、焊线塑封,使电路与外部器件实现连接,并为半导体产品提供机械保护,使其免受物理、化学等环境因素损失的工艺。
半导体封装技术发展大致分为四个阶段,全球封装技术的主流处于第三代的成熟期,主要是CSP、BGA封装技术,目前封测行业正在从传统封装向先进封装转型。
随着半导体先进制程不断往7nm/5nm,甚至以下迈进,晶片设计与制造工艺微缩的难度、成本与开发时间均呈现跳跃式的增长。
面对此难题,晶片业者试图透过先进封装来达到晶片间的高密度互联,以实现以更低成本提供同等级效能表现。
先进封装采用了先进的设计思路和先进的集成工艺,对芯片进行封装级重构,并且能有效提升系统高功能密度的封装技术。
先进封装工艺包括倒装焊(FlipChip)、晶圆级封装(WLP)、2.5D封装(Interposer) 、3D封装 (TSV)、Chiplet等。
芯片整合已演进至2.5D/3D及Chiplet封装:
二、Chiplet:先进封装代表
Chiplet又称芯粒或小芯片,是先进封装技术的代表,将复杂芯片拆解成一组具有单独功能的小芯片单元 die(裸片),通过 die-to-die 将模块芯片和底层基础芯片封装组合在一起。
Chiplet 实现原理与搭积木相仿,从设计时就按照不同的计算单元或功能单元对其进行分解,然后每个单元选择最适合的工艺制程进行制造,再将这些模块化的裸片互联起来,通过先进封装技术,将不同功能、不同工艺制造的Chiplet封装成一个系统芯片,以实现一种新形式的 IP 复用。
Chiplet 的概念源于 Marvell 创始人周秀文博士在 ISSCC 2015 上提出的 Mochi(Modular Chip,模块化芯片)架构,伴随着 AMD 第一个将小芯片架构引入其最初的 Epyc 处理器 Naples,Chiplet 技术快速发展。
通过Chiplet技术,使用10nm工艺制造出来的芯片,完全也可以达到7nm芯片的集成度,但是研发投入和一次性生产投入则比7nm芯片的投入要少的多,新的连接形式在其生产过程中带动设备需求。
三、晶圆级扇出封装(FOWLP)
晶圆级扇出封装在封装工艺上需要先将晶圆进行切割,挑出KGD(Known Good Die)排列放置于圆型铜质载板上,再继续后面的封装步骤。由于有事先切割、挑出KGD及重新配置的步骤,因此晶圆级扇出封装具有异构集成特性,即不同功能的芯片可以组装在一个封装中。晶圆级扇入封装(WLCSP)由于直接在晶圆上完成封装和测试,然后才切割成单独的集成电路,因而不具备异构集成特性。多个芯片异构集成与具有高集成度的单个芯片相比,具有成本低、良率好、产量高等优点;与分立的多个单一芯片封装相比,异构集成各芯片之间的互连比PCB布线短、RC延迟低、性能好。异构集成不局限于硅片,还可以是MEMS,滤波器和无源器件,从而更好地发挥扇出的电气连接优势。
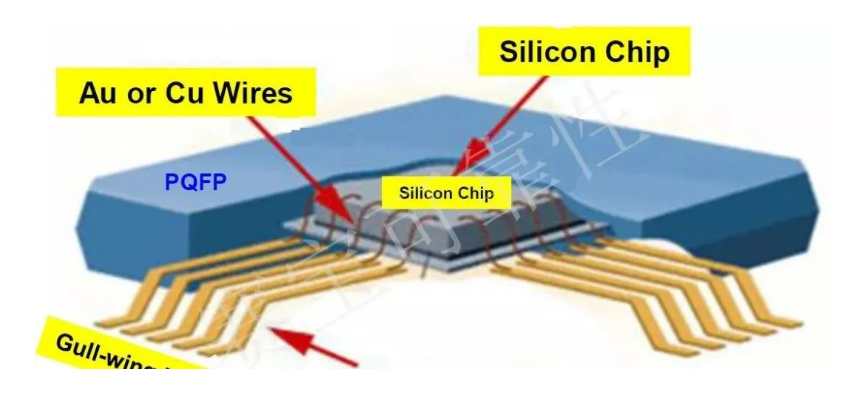
图2 传统含有引线框架的封装

(a) 晶圆级扇出封装横截面示意图
UBM: Under Bump Metalization
RDL: Re-distribution Layer
KGD: Known good die
EMC: Epoxy molding compound
四、2.5D / 3D 封装
3D与2.5D的区别在于芯片之间的相对位置是并排还是堆叠,互连方式是水平还是垂直,这个关键区别决定了3D与2.5D集成密度的不同。早期的3D封装也是通过引线键合形成互连并且连接到引线框架,例如常见的叠层Flash/DDR芯片。为了减少信号损失,提高集成密度,更好地发挥3D技术优势,新型3D封装搭配TSV技术,堆叠的多层芯片通过TSV连接起来。

图4 典型2.5D封装
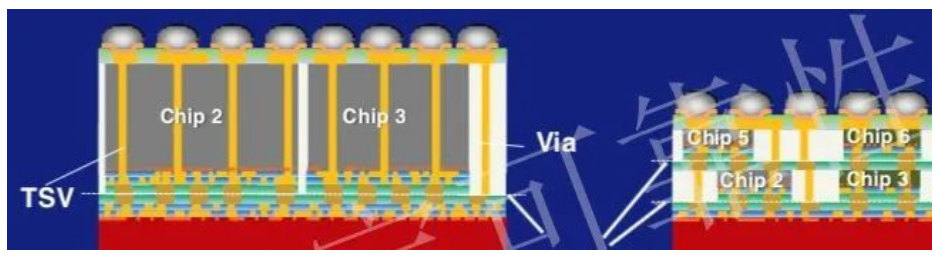
图5 典型的3D封装
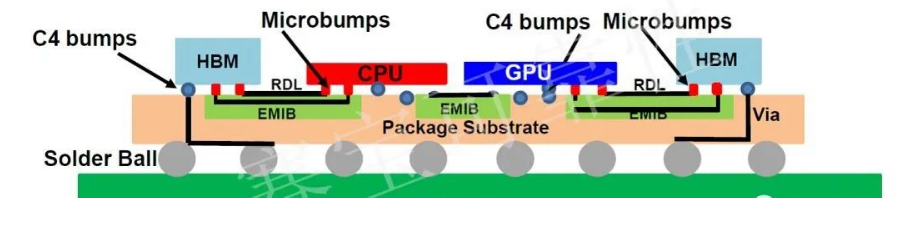
图6 含EMIB的3D封装
五、先进封装产品清洗剂:
先进封装产品芯片焊后封装前,基板载板焊盘上的污染物有多种,可归纳为离子型和非离子型两大类。离子型污染物接触到环境中的湿气,通电后发生电化学迁移,形成树枝状结构体,造成低电阻通路,破坏了电路板功能。非离子型污染物可穿透PC B 的绝缘层,在PCB板表层下生长枝晶。除了离子型和非离子型污染物,还有粒状污染物,例如焊料球、焊料槽内的浮点、灰尘、尘埃等,这些污染物会导致焊点质量降低、焊接时焊点拉尖、产生气孔、短路等等多种不良现象。
这么多污染物,到底哪些才是最备受关注的呢?助焊剂或锡膏普遍应用于回流焊和波峰焊工艺中,它们主要由溶剂、润湿剂、树脂、缓蚀剂和活化剂等多种成分,焊后必然存在热改性生成物,这些物质在所有污染物中的占据主导,从产品失效情况来而言,焊后残余物是影响产品质量最主要的影响因素,离子型残留物易引起电迁移使绝缘电阻下降,松香树脂残留物易吸附灰尘或杂质引发接触电阻增大,严重者导致开路失效,因此焊后必须进行严格的清洗,才能保障电路板的质量。
针对先进封装产品芯片焊后封装前,基板载板焊盘、电子制程精密焊后清洗的不同要求, 在水基清洗方面有比较丰富的经验,对于有着低表面张力、低离子残留、配合不同清洗工艺使用的情况,自主开发了较为完整的水基系列产品,精细化对应涵盖从半导体封装到PCBA组件终端,包括有水基清洗剂和半水基清洗剂,碱性水基清洗剂和中性水基清洗剂等。具体表现在,在同等的清洗力的情况下, 的兼容性较佳,兼容的材料更为广泛;在同等的兼容性下, 的清洗剂清洗的锡膏种类更多(测试过的锡膏品种有ALPHA、SMIC、INDIUM、SUPER-FLEX、URA、TONGFANG、JISSYU、HANDA、OFT、WTO等品牌;测试过的焊料合金包括SAC305、SAC307、6337、925等不同成分),清洗速度更快,离子残留低、干净度更好。
【阅读提示】
以上为本公司一些经验的累积,因工艺问题内容广泛,没有面面俱到,只对常见问题作分析,随着电子产业的不断更新换代,新的工艺问题也不断出现,本公司自成立以来不断的追求产品的创新,做到与时俱进,熟悉各种生产复杂工艺,能为各种客户提供全方位的工艺、设备、材料的清洗解决方案支持。
【免责声明】
1. 以上文章内容仅供读者参阅,具体操作应咨询技术工程师等;
2. 内容为作者个人观点, 并不代表本网站赞同其观点和对其真实性负责,本网站只提供参考并不构成投资及应用建议。本网站上部分文章为转载,并不用于商业目的,如有涉及侵权等,请及时告知我们,我们会尽快处理;
3. 除了“转载”之文章,本网站所刊原创内容之著作权属于
网站所有,未经本站之同意或授权,任何人不得以任何形式重制、转载、散布、引用、变更、播送或出版该内容之全部或局部,亦不得有其他任何违反本站著作权之行为。“转载”的文章若要转载,请先取得原文出处和作者的同意授权;
4. 本网站拥有对此声明的最终解释权。





