先进封装之 - 2.5D封装
先进封装之 - 2.5D封装
电子集成技术分为三个层次,芯片上的集成,封装内的集成,PCB板级集成,其代表技术分别为SoC,SiP和PCB(也可以称为SoP或者SoB)
芯片上的集成主要以2D为主,晶体管以平铺的形式集成于晶圆平面;同样,PCB上的集成也是以2D为主,电子元器件平铺安装在PCB表面,因此,二者都属于2D集成。而针对于封装内的集成,情况就要复杂的多。
电子集成技术分类的两个重要判据:1.物理结构,2.电气连接(电气互连)。
目前先进封装中按照主流可分为2D封装、2.5D封装、3D封装三种类型。今天小编给大家带来的是2.5D封装,希望能对大家有所帮助!

2.5D封装:
2.5D封装通常是指既有2D的特点,又有部分3D的特点,其中的代表技术包括英特尔的EMIB、台积电的CoWoS、三星的I-Cube。
物理结构:所有芯片和无源器件均XY平面上方,至少有部分芯片和无源器件安装在中介层上(Interposer),在XY平面的上方有中介层的布线和过孔,在XY平面的下方有基板的布线和过孔。
电气连接:中介层(Interposer)可提供位于中介层上的芯片的电气连接。
2.5D集成的关键在于中介层Interposer,一般会有几种情况,1)中介层是否采用硅转接板,2)中介层是否采用TSV,3)采用其他类型的材质的转接板;在硅转接板上,我们将穿越中介层的过孔称之为TSV,对于玻璃转接板,我们称之为TGV
所谓的TSV 指的是:
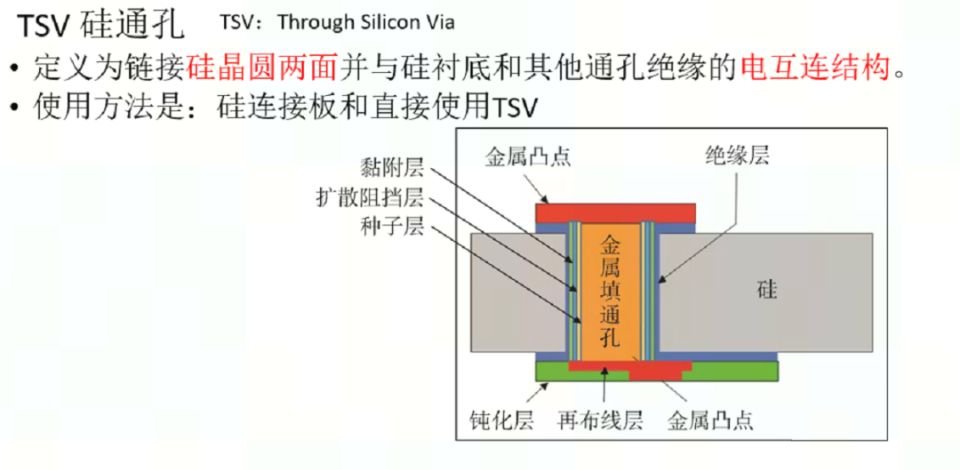
硅中介层有TSV的集成是最常见的一种2.5D集成技术,芯片通常通过MicroBump和中介层相连接,作为中介层的硅基板采用Bump和基板相连,硅基板表面通过RDL布线,TSV作为硅基板上下表面电气连接的通道,这种2.5D集成适合芯片规模比较大,引脚密度高的情况,芯片一般以FlipChip形式安装在硅基板上。
有TSV的2.5D集成示意图:
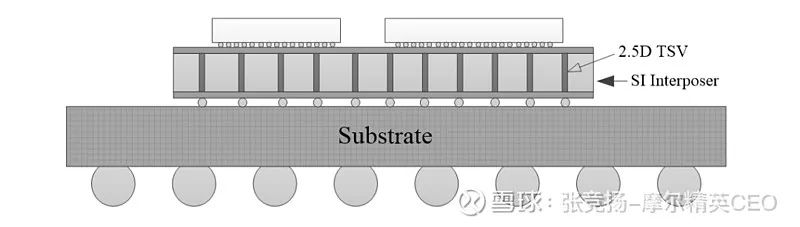
硅中介层无TSV的2.5D集成的结构一般如下图所示,有一颗面积较大的裸芯片直接安装在基板上,该芯片和基板的连接可以采用Bond Wire或者Flip Chip两种方式,大芯片上方由于面积较大,可以安装多个较小的裸芯片,但小芯片无法直接连接到基板,所以需要插入一块中介层(Interposer),在中介层上方安装多个裸芯片,中介层上有RDL布线,可将芯片的信号引出到中介层的边沿,然后通过Bond Wire连接到基板。这类中介层通常不需要TSV,只需要通过Interposer上表面的布线进行电气互连,Interposer采用Bond Wire和封装基板连接。
无TSV的2.5D集成示意图:

英特尔的EMIB:
概念与2.5D封装类似,但与传统2.5D封装的区别在于没有TSV。也正是这个原因,EMIB技术具有正常的封装良率、无需额外工艺和设计简单等优点。
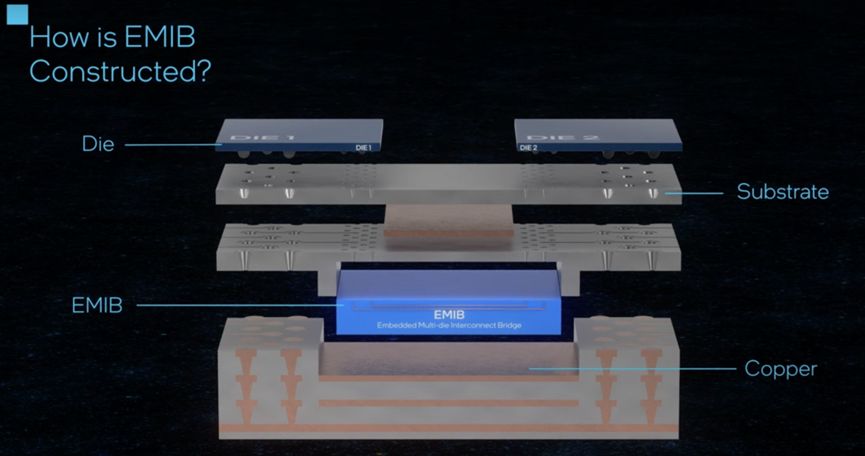
台积电的CoWoS技术
台积电的CoWoS技术也是一种2.5D封装技术。根据中介层的不同可以分为三类,一种是CoWoS_S使用Si衬底作为中介层,另一种是CoWoS_R使用RDL作为中介层,第三种是CoWoS_L使用小芯片(Chiplet)和RDL作为中介层。
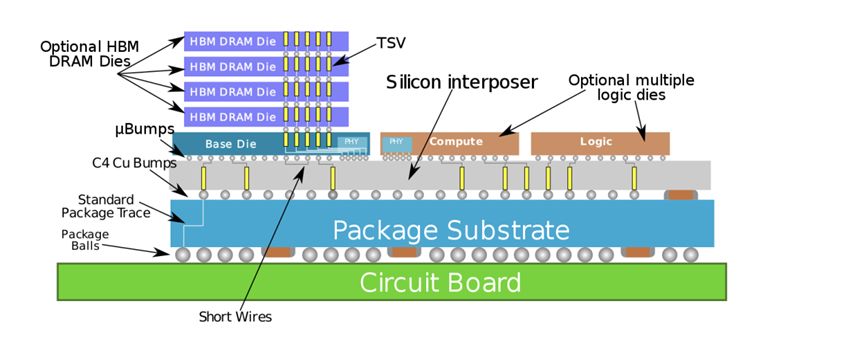
台积电InFO(2D)与CoWoS(2.5D)之间的区别在于,CoWoS针对高端市场,连线数量和封装尺寸都比较大;InFO针对性价比市场,封装尺寸较小,连线数量也比较少。
第一代CoWoS主要用于大型FPGA。CoWoS-1的中介层芯片面积高达约800mm?,非常接近掩模版限制。第二代CoWoS通过掩模拼接显着增加了中介层尺寸。台积电最初符合1200mm?的要求,此后将中介层尺寸增加到1700mm?。这些大型封装称为CoWoS-XL2。
最近,台积电公布的第五代CoWoS-S的晶体管数量将增加20倍,中介层面积也会提升3倍。第五代封装技术还将封装8个128G的HBM2e内存和2颗大型SoC内核。
长电科技XDFOI技术:
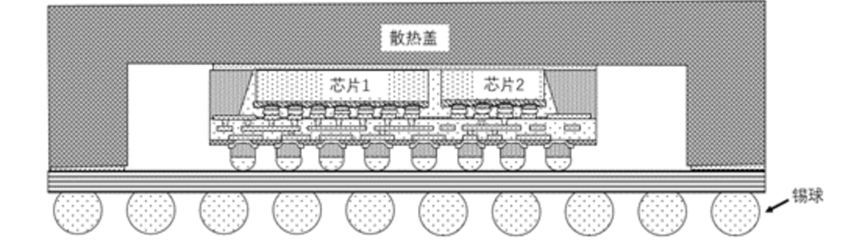
相较于2.5D TSV封装技术,具备更高性能、更高可靠性以及更低成本等特性。该解决方案在线宽或线距可达到2um的同时,可实现多层布线层,另外,采用了极窄节距凸块互联技术,封装尺寸大,可集成多颗芯片、高带宽内存和无源器件。
三星的I-Cube
三星的具有的先进封装包括I-Cube、X-Cube、R-Cube和H-Cube四种方案。其中,三星的I-Cube同样也属于2.5D封装。
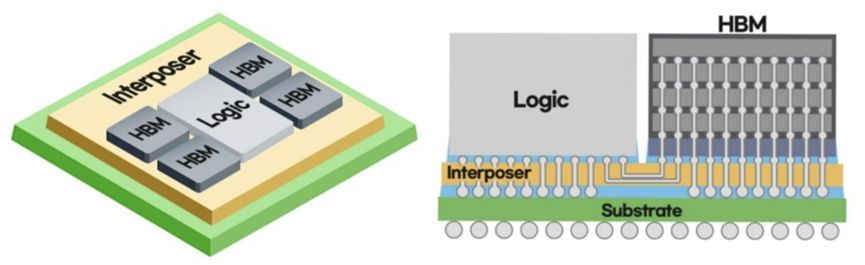
以上是关于先进封装之 - 2.5D封装的相关内容,希望能您你有所帮助!
想要了解关于芯片半导体清洗的相关内容,请访问我们的“芯片半导体清洗”专题了解相关产品与应用 !
是一家电子水基清洗剂 环保清洗剂生产制造商,其产品覆盖电子加工过程整个领域。欢迎使用 水基清洗剂产品!
【阅读提示】
以上为本公司一些经验的累积,因工艺问题内容广泛,没有面面俱到,只对常见问题作分析,随着电子产业的不断更新换代,新的工艺问题也不断出现,本公司自成立以来不断的追求产品的创新,做到与时俱进,熟悉各种生产复杂工艺,能为各种客户提供全方位的工艺、设备、材料的清洗解决方案支持。
【免责声明】
1. 以上文章内容仅供读者参阅,具体操作应咨询技术工程师等;
2. 内容为作者个人观点, 并不代表本网站赞同其观点和对其真实性负责,本网站只提供参考并不构成投资及应用建议。本网站上部分文章为转载,并不用于商业目的,如有涉及侵权等,请及时告知我们,我们会尽快处理;
3. 除了“转载”之文章,本网站所刊原创内容之著作权属于
网站所有,未经本站之同意或授权,任何人不得以任何形式重制、转载、散布、引用、变更、播送或出版该内容之全部或局部,亦不得有其他任何违反本站著作权之行为。“转载”的文章若要转载,请先取得原文出处和作者的同意授权;
4. 本网站拥有对此声明的最终解释权。





