半导体封装工艺的等级、作用、发展趋势和清洗介绍
发布日期:2023-06-09
发布者:
浏览次数:4777
一、半导体封装工艺的四个等级
电子封装技术与器件的硬件结构有关。这些硬件结构包括有源元件1(如半导体)和无源元件2(如电阻器和电容器3)。因此,电子封装技术涵盖的范围较广,可分为0级封装到3级封装等四个不同等级。图1展示了半导体封装工艺的整个流程。首先是0级封装,负责将晶圆切割出来;其次是1级封装,本质上是芯片级封装;接着是2级封装,负责将芯片安装到模块或电路卡上;最后是3级封装,将附带芯片和模块的电路卡安装到系统板上。从广义上讲,整个工艺通常被称为“封装”或“装配”。然而,在半导体行业,半导体封装一般仅涉及晶圆切割和芯片级封装工艺。1有源元件:一种需要外部电源才能实现其特定功能的器件,就像半导体存储器或逻辑半导体。2无源元件:一种不具备放大或转换电能等主动功能的器件。3电容器(Capacitor):一种储存电荷并提供电容量的元件。
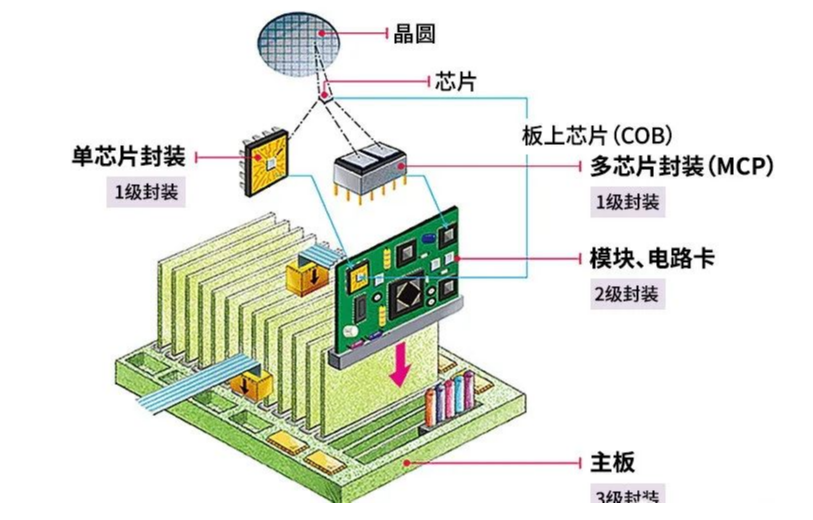
▲图1:半导体的封装等级
封装通常采用细间距球栅阵列(FBGA)或薄型小尺寸封装(TSOP)的形式,如图2所示。FBGA封装中的锡4球和TSOP封装中的引线5分别充当引脚,使封装的芯片能够与外部组件之间实现电气和机械连接。
4锡(Solder):一种低熔点金属,支持电气和机械键合。5引线(Lead):从电路或元件终端向外引出的导线,用于连接至电路板。

▲图2:半导体封装示例
二、 半导体封装的作用
图3展示了半导体封装的四个主要作用,包括机械保护、电气连接、机械连接和散热。其中,半导体封装的主要作用是通过将芯片和器件密封在环氧树脂模塑料(EMC)等封装材料中,保护它们免受物理性和化学性损坏。尽管半导体芯片由数百个晶圆工艺制成,用于实现各种功能,但主要材质是硅。硅像玻璃一样,非常易碎。而通过众多晶圆工艺形成的结构同样容易受到物理性和化学性损坏。因此,封装材料对于保护芯片至关重要。

▲图3:半导体封装的作用
此外,半导体封装可以实现从芯片到系统之间的电气和机械连接。封装通过芯片和系统之间的电气连接来为芯片供电,同时为芯片提供信号的输入和输出通路。在机械连接方面,需将芯片可靠地连接至系统,以确保使用时芯片和系统之间连接良好。同时,封装需将半导体芯片和器件产生的热量迅速散发出去。在半导体产品工作过程中,电流通过电阻时会产生热量。如图3所示,半导体封装将芯片完全地包裹了起来。如果半导体封装无法有效散热,则芯片可能会过热,导致内部晶体管升温过快而无法工作。因此,对于半导体封装技术而言,有效散热至关重要。随着半导体产品的速度日益加快,功能日益增多,封装的冷却功能也变得越来越重要。
三、半导体封装的发展趋势
图4概述了近年来半导体封装技术的六大发展趋势。分析这些趋势有助于我们了解封装技术如何不断演变并发挥作用。首先,由于散热已经成为封装工艺的一个重要因素,因此人们开发出了热传导6性能较好的材料和可有效散热的封装结构。6热传导:指在不涉及物质转移的情况下,热量从温度较高的部位传递到相邻温度较低部位的过程。可支持高速电信号传输的封装技术也成为了一种重要发展趋势,因为封装会限制半导体产品的速度。例如,将一个速度达每秒20千兆 (Gbps) 的半导体芯片或器件连接至仅支持每秒2千兆(Gbps) 的半导体封装装置时,系统感知到的半导体速度将为每秒2千兆 (Gbps)。由于连接至系统的电气通路是在封装中创建,因此无论芯片的速度有多快,半导体产品的速度都会极大地受到封装的影响。这意味着,在提高芯片速度的同时,还需要提升半导体封装技术,从而提高传输速度。这尤其适用于人工智能技术和5G无线通信技术。鉴于此,倒片封装7和硅通孔(TSV)8等封装技术应运而生,为高速电信号传输提供支持。7倒片封装(Flip Chip):一种通过将凸点朝下安装于基板上,将芯片与基板连接的互连技术。8硅通孔(TSV):一种可完全穿过硅裸片或晶圆实现硅片堆叠的垂直互连通道。

▲图4:半导体封装技术的发展趋势
四、半导体封装清洗
半导体芯片封装过程中通常会使用助焊剂和锡膏等作为焊接辅料,这些辅料在焊接过程或多或少都会有部分残留物,还包括制程中沾污的指印、汗液、角质和尘埃等污染物。同时,半导体组装了铝、铜、铂、镍等敏感金属和油墨字符、电磁碳膜和特殊标签等相当脆弱的功能材料。这些敏感金属和特殊功能材料对清洗剂的兼容性提出了很高的要求。
合明半水基清洗工艺解决方案,可在清洗芯片封装基板的焊接残留物和污垢的同时去除金属界面高温氧化膜,保障下一道工序的金属界面结合强度;对芯片半导体基材、金属材料拥有优良的材料兼容性,清洗后易于用水漂洗干净。
欢迎使用
半水基清洗剂W3300!
以上便是芯片封装基板清洗,封装基板的主要结构和生产技术的介绍,希望可以帮到您!
Tips:
【阅读提示】
以上为本公司一些经验的累积,因工艺问题内容广泛,没有面面俱到,只对常见问题作分析,随着电子产业的不断更新换代,新的工艺问题也不断出现,本公司自成立以来不断的追求产品的创新,做到与时俱进,熟悉各种生产复杂工艺,能为各种客户提供全方位的工艺、设备、材料的清洗解决方案支持。
【免责声明】
1. 以上文章内容仅供读者参阅,具体操作应咨询技术工程师等;
2. 内容为作者个人观点, 并不代表本网站赞同其观点和对其真实性负责,本网站只提供参考并不构成投资及应用建议。本网站上部分文章为转载,并不用于商业目的,如有涉及侵权等,请及时告知我们,我们会尽快处理;
3. 除了“转载”之文章,本网站所刊原创内容之著作权属于
网站所有,未经本站之同意或授权,任何人不得以任何形式重制、转载、散布、引用、变更、播送或出版该内容之全部或局部,亦不得有其他任何违反本站著作权之行为。“转载”的文章若要转载,请先取得原文出处和作者的同意授权;
4. 本网站拥有对此声明的最终解释权。