将芯片固定于封装基板上的工艺 - 芯片键合(Die Bonding)
将芯片固定于封装基板上的工艺 - 线片键合(Die Bonding)
作为半导体制造的后段工序,封装工艺包含背面研磨(Back Grinding)、划片(Dicing)、芯片键合(Die Bonding)、引线键合(Wire Bonding)及成型(Molding)等步骤。这些工艺的顺序可根据封装技术的变化进行调整、相互结合或合并。在上一期中,我们介绍了将晶圆切割成单个芯片的划片工艺。今天小编就给大家介绍一下芯片键合(die bonding)工艺,采用这种封装工艺可在划片工艺之后将从晶圆上切割的芯片黏贴在封装基板(引线框架或印刷电路板)上。
1、什么是键合(Bonding)?
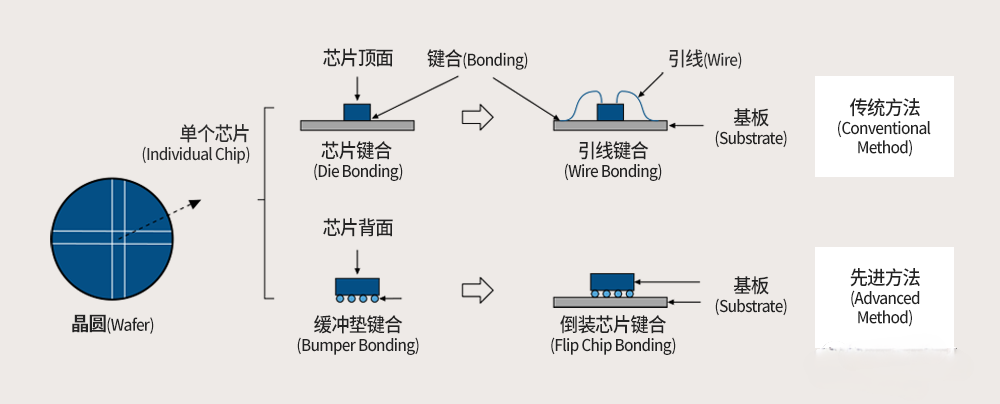
图1. 键合类型
在半导体工艺中,“键合”是指将晶圆芯片固定于基板上。键合工艺可分为传统方法和先进方法两种类型。传统方法采用芯片键合(Die Bonding)(或芯片贴装(Die Attach))和引线键合(Wire Bonding),而先进方法则采用IBM于60年代后期开发的倒装芯片键合(Flip Chip Bonding)技术。倒装芯片键合技术将芯片键合与引线键合相结合,并通过在芯片焊盘上形成凸块(Bump)的方式将芯片和基板连接起来。
就像发动机用于为汽车提供动力一样,芯片键合技术通过将半导体芯片附着到引线框架(Lead Frame)或印刷电路板(PCB, Printed Circuit Board)上,来实现芯片与外部之间的电连接。完成芯片键合之后,应确保芯片能够承受封装后产生的物理压力,并能够消散芯片工作期间产生的热量。必要时,必须保持恒定导电性或实现高水平的绝缘性。因此,随着芯片尺寸变得越来越小,键合技术变得越来越重要。
2、芯片键合步骤

图2. 芯片键合与倒装芯片键合之间的比较
在芯片键合过程中,首先需在封装基板上点上粘合剂。接着,将芯片顶面朝上放置在基板上。与此相反,倒装芯片键合则是一种更加先进的技术,首先,将称为“焊球(Solder Ball)”的小凸块附着在芯片焊盘上。其次,将芯片顶面朝下放置在基板上。在这两种方法中,组装好的单元将经过一个被称为温度回流(Temperature Reflow)的通道,该通道可随着时间的推移调节温度,以熔化粘合剂或焊球。然后,在其冷却后将芯片(或凸块)固定到基板上。
3、芯片拾取与放置(Pick & Place)

图3. 芯片拾取和放置
逐个移除附着在切割胶带上数百个芯片的过程称为“拾取”。使用柱塞从晶圆上拾取合格芯片并将其放置在封装基板表面的过程称为“放置”。这两项任务合称为“拾取与放置”,均在固晶机1上完成。完成对所有合格芯片的芯片键合之后,未移除的不合格芯片将留在切割胶带上,并在框架回收时全部丢弃。在这个过程中,将通过在映射表2中输入晶圆测试结果(合格/不合格)的方式对合格芯片进行分类。
4、芯片顶出(Ejection)工艺

图4. 芯片顶出工艺:在三个方向施加力时的放大图
完成划片工艺之后,芯片将被分割成独立模块并轻轻附着在切割胶带(Dicing Tape)上。此时,逐个拾取水平放置在切割胶带上的芯片并不容易。因为即使使用真空也很难轻易拾取芯片,如果强行拉出,则会对芯片造成物理损坏。
为此,可采用“顶出(Ejection)工艺”,通过顶出装置3对目标芯片施加物理力,使其与其它芯片形成轻微步差,从而轻松拾取芯片。顶出芯片底部之后,可使用带有柱塞的真空吸拾器从上方拉出芯片。与此同时,使用真空吸拾器将切割胶带底部拉起,以使晶圆保持平整。
5、使用环氧树脂(Epoxy)实现粘合的芯片键合工艺
在执行芯片键合时,可使用金或银(或镍)制成合金,特别是对于大型密封封装。也可通过使用焊料或含有金属的糊剂(Power Tr)进行连接,或使用聚合物-聚酰亚胺(Polymer, Polyimide)进行芯片键合。在高分子材料中,含银糊状或液体型环氧树脂(Epoxy)相对易于使用且使用频率较高。
使用环氧树脂进行芯片键合时,可将极少量环氧树脂精确地点在基板上。将芯片放置在基板上之后,通过回流(Reflow)或固化(Curing),在150°C至250°C的温度条件下使环氧树脂硬化,以将芯片和基板粘合在一起。此时,若所使用环氧树脂的厚度不恒定,则会因膨胀系数差异而导致翘曲(Warpage),从而引起弯曲或变形。因此,尽管使用少量环氧树脂较为有利,但只要使用环氧树脂就会发生不同形式的翘曲。
正因为如此,一种使用晶片黏结薄膜(Die Attach Film, DAF)的先进键合方法成为近年来的首选方法。尽管DAF具有价格昂贵且难以处理的缺点,但却易于掌握使用量,简化了工艺,因此使用率正在逐渐增加。
6、使用晶片黏结薄膜(DAF)的芯片键合工艺
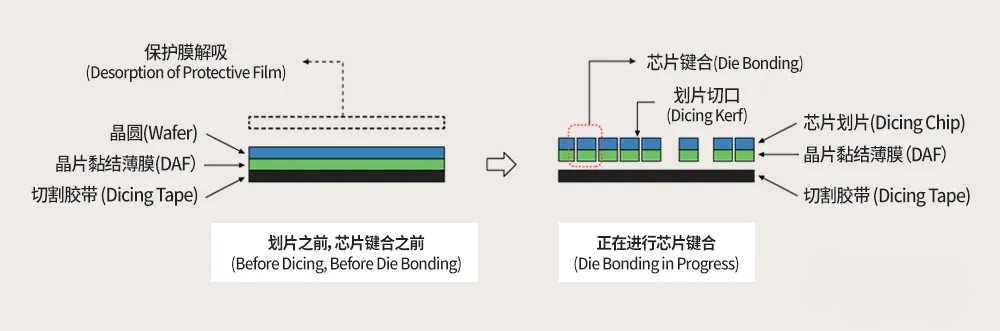
图6. 使用晶片黏结薄膜(DAF)的芯片键合工艺
以上是关于将芯片固定于封装基板上的工艺 - 芯片键合的相关内容了,希望能对您有所帮助!
想要了解关于芯片半导体清洗的相关内容,请访问我们的“芯片半导体清洗”专题了解相关产品与应用 !
是一家电子水基清洗剂 环保清洗剂生产厂家,其产品覆盖电子加工过程整个领域。欢迎使用 水基清洗剂产品!
【阅读提示】
以上为本公司一些经验的累积,因工艺问题内容广泛,没有面面俱到,只对常见问题作分析,随着电子产业的不断更新换代,新的工艺问题也不断出现,本公司自成立以来不断的追求产品的创新,做到与时俱进,熟悉各种生产复杂工艺,能为各种客户提供全方位的工艺、设备、材料的清洗解决方案支持。
【免责声明】
1. 以上文章内容仅供读者参阅,具体操作应咨询技术工程师等;
2. 内容为作者个人观点, 并不代表本网站赞同其观点和对其真实性负责,本网站只提供参考并不构成投资及应用建议。本网站上部分文章为转载,并不用于商业目的,如有涉及侵权等,请及时告知我们,我们会尽快处理;
3. 除了“转载”之文章,本网站所刊原创内容之著作权属于
网站所有,未经本站之同意或授权,任何人不得以任何形式重制、转载、散布、引用、变更、播送或出版该内容之全部或局部,亦不得有其他任何违反本站著作权之行为。“转载”的文章若要转载,请先取得原文出处和作者的同意授权;
4. 本网站拥有对此声明的最终解释权。





