先进封装之面板芯片级封装(PLCSP)技术介绍与芯片封装清洗概述
相对于晶圆级封装,面板级封装是一种更高效的封装技术。这得益于两大优势:面积利用率比晶圆级封装高以及面板通常面积比晶圆面积大得多。由于晶圆的圆形和芯片的矩形不一致,取决于芯片的大小,通常在封装过程中硅晶圆面积浪费掉10-20%。而面板本身是矩形的,所以可以大大减少边角料的浪费。另外,常见的面板有18寸乘24寸,20寸乘 20寸,510 mm乘515 mm,600 mm乘600 mm,甚至700 mm乘700 mm等等,是晶圆面积的3-7倍。一个面板上可以放置多个晶圆。
今天我们来介绍PLCSP(Panel Level Chip Scale Packaging)。
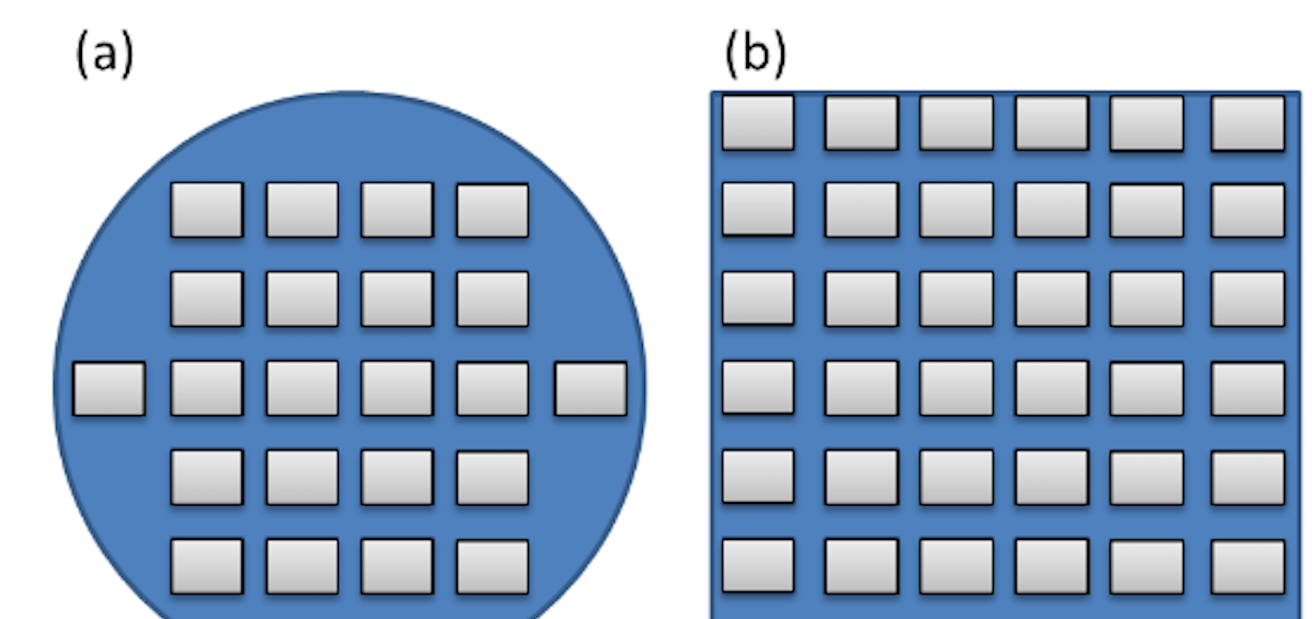

a.面板载板清洗,面板可以是金属的,也可以是玻璃或其他材料;
b.在面板载板上贴上双面热离型胶膜,我们也可以考虑光解键合胶,其相应地载板材料通常是可以通光的玻璃载板;
c.在另一个面板模具(通常是PCB面板)上制作相应的空腔。如图二所示,我们需要一个300毫米的全圆,两个半圆和一个四分之一圆。这个模具通常是用激光来加工的;
d.将带空腔的面板模具粘到连接到面板载板上;
e.将未切割和切割好的晶圆放进模具的空腔中,并由step b中的双面胶固定;
f.在整个面板上层压ABF介质层,通常ABF的厚度在15-50微米。它的功能就像常用的聚酰亚胺一样,但是ABF的成本要远低于聚酰亚胺。然而,基于ABF的重布层的线距线宽会远大于聚酰亚胺所能提供的;
g.在ABF介质层上激光钻通孔。常用的激光器有二氧化碳激光,UV激光器。光束顶部通孔的典型直径为50-100微米,由于via侧壁存在taper angle底部孔直接要比ABF上表面开口要小些;
h.Desmear去污,同时使得ABF表面更加粗糙来增加金属层的粘附力;
i.通常是化学镀种子层铜,在特殊情况下我们也可以用PVD物理气相沉积来形成种子层;
j.光刻胶涂敷,由于面板的矩形,spin coating很少被用到。常用的方法有薄膜压层,液体光刻胶的slit coating and spray coating,干膜光刻胶是最常用的材料;
k.通过曝光显影等来定义金属层结构,我们可以用LDI激光直写的方式或者用掩模版stepper方法;
l.在光刻胶开口处电镀铜,也可以根据需要来电镀镍钯金;
m.剥离光刻胶;
n.蚀刻掉钛铜种子层;
o.根据需要,可以重复step g至n来增加buildup layer数量;
p.在整个晶片上溅射钛铜种子层;
q.在表面介质层,通常solder resist,也可以是PI等材料;
r.在表面介质层使用激光打孔或者曝光显影等方式在bump pads处开口;
s.形成种子层;
t.涂上光刻胶和掩模,然后用光刻技术打开凸点焊盘上的通孔以暴露带有 UBM 的区域;
u.电镀铜芯;
v.电镀焊料,通常是SnAg等材料。也可以使用直接植球的方式;
w.剥离光刻胶;
x.蚀刻掉钛铜种子层;
y.涂抹助焊剂并回流焊料;
z.从载板上debond所有的晶圆;

PLCSP 芯片封装基板的助焊剂清洗剂:
半导体芯片封装过程中通常会使用助焊剂和锡膏等作为焊接辅料,这些辅料在焊接过程或多或少都会有部分残留物,还包括制程中沾污的指印、汗液、角质和尘埃等污染物。同时,半导体组装了铝、铜、铂、镍等敏感金属和油墨字符、电磁碳膜和特殊标签等相当脆弱的功能材料。这些敏感金属和特殊功能材料对清洗剂的兼容性提出了很高的要求。
合明半水基清洗工艺解决方案,可在清洗芯片封装基板的焊接残留物和污垢的同时去除金属界面高温氧化膜,保障下一道工序的金属界面结合强度;对芯片半导体基材、金属材料拥有优良的材料兼容性,清洗后易于用水漂洗干净。
欢迎使用 半水基清洗剂W3300!
以上便是芯片封装基板清洗,封装基板的主要结构和生产技术的介绍,希望可以帮到您!
【阅读提示】
以上为本公司一些经验的累积,因工艺问题内容广泛,没有面面俱到,只对常见问题作分析,随着电子产业的不断更新换代,新的工艺问题也不断出现,本公司自成立以来不断的追求产品的创新,做到与时俱进,熟悉各种生产复杂工艺,能为各种客户提供全方位的工艺、设备、材料的清洗解决方案支持。
【免责声明】
1. 以上文章内容仅供读者参阅,具体操作应咨询技术工程师等;
2. 内容为作者个人观点, 并不代表本网站赞同其观点和对其真实性负责,本网站只提供参考并不构成投资及应用建议。本网站上部分文章为转载,并不用于商业目的,如有涉及侵权等,请及时告知我们,我们会尽快处理;
3. 除了“转载”之文章,本网站所刊原创内容之著作权属于
网站所有,未经本站之同意或授权,任何人不得以任何形式重制、转载、散布、引用、变更、播送或出版该内容之全部或局部,亦不得有其他任何违反本站著作权之行为。“转载”的文章若要转载,请先取得原文出处和作者的同意授权;
4. 本网站拥有对此声明的最终解释权。





